Hot Posts
The AMD Ryzen AI 9 HX 370 Review: Unleashing Zen 5 and RDNA 3.5 Into Notebooks
During the opening keynote delivered by AMD CEO Dr. Lisa Su at Computex 2024, AMD finally lifted the lid on their highly-anticipated Zen 5 microarchitecture. The backbone for the next couple of years of everything CPU at AMD, the company unveiled their plans to bring Zen 5 in the consumer market, announcing both their next-generation mobile and desktop products at the same time. With a tight schedule that will see both platforms launch within weeks of each other, today AMD is taking their first step with the launch of the Ryzen AI 300 series – codenamed Strix Point – their new Zen 5-powered mobile SoC.
The latest and greatest from AMD, the Strix Point brings significant architectural improvements across AMD's entire IP portfolio. Headlining the chip, of course, is the company's new Zen 5 CPU microarchitecture, which is taking multiple steps to improve on CPU performance without the benefits of big clockspeed gains. And reflecting the industry's current heavy emphasis on AI performance, Strix Point also includes the latest XDNA 2-based NPU, which boasts up to 50 TOPS of performance. Other improvements include an upgraded integrated graphics processor, with AMD moving to the RDNA 3.5 graphics architecture.
The architectural updates in Strix Point are also seeing AMD opt for a heterogenous CPU design from the very start, incorporating both performance and efficiency cores as a means of offering better overall performance in power-constrained devices. AMD first introduced their compact Zen cores in the middle of the Zen 4 generation, and while they made it into products such as AMD's small-die Phoenix 2 platform, this is the first time AMD's flagship mobile silicon has included them as well. And while this change is going to be transparent from a user perspective, under the hood it represents an important improvement in CPU design. As a result, all Ryzen AI 300 chips are going to include a mix of not only AMD's (mostly) full-fat Zen 5 CPU cores, but also their compact Zen 5c cores, boosting the chips' total CPU core counts and performance in multi-threaded situations.
For today's launch, the AMD Ryzen AI 300 series will consist of just three SKUs: the flagship Ryzen AI 9 HX 375, with 12 CPU cores, as well as the Ryzen AI 9 HX 370 and Ryzen 9 365, with 12 and 10 cores respectively. All three SoCs combine both the regular Zen 5 core with the more compact Zen 5c cores to make up the CPU cluster, and are paired with a powerful Raden 890M/880M GPU, and a XDNA 2-based NPU.
As the successor to the Zen 4-based Phoenix/Hawk Point, the AMD Ryzen AI 300 series is targeting a diverse and active notebook market that has become the largest segment of the PC industry overall. And it is telling that, for the first time in the Zen era, AMD is launching their mobile chips first – if only by days – rather than their typical desktop-first launch. It's both a reflection on how the PC industry has changed over the years, and how AMD has continued to iterate and improve upon its mobile chips; this is as close to mobile-first as the company has ever been.
Getting down to business, for our review of the Ryzen AI 300 series, we are taking a look at ASUS's Zenbook S 16 (2024), a 16-inch laptop that's equipped with AMD's Ryzen AI 9 HX 370. The sightly more modest Ryzen features four Zen 5 CPU cores and 8 Zen 5c CPU cores, as well as AMD's latest RDNA 3.5 Radeon 890M integrated graphics. Overall, the HX 370 has a configurable TDP of between 15 and 54 W, depending on the desired notebook configuration.
Fleshing out the rest of the Zenbook S 16, ASUS has equipped the laptop with a bevy of features and technologies fitting for a flagship Ryzen notebook. The centerpiece of the laptop is a Lumina OLED 16-inch display, with a resolution of up to 2880 x 1800 and a variable 120 Hz refresh rate. Meanwhile, inside the Zenbook S 16 is 32 GB of LPDDR5 memory and a 1 TB PCIe 4.0 NVMe SSD. And while this is a 16-inch class notebook, ASUS has still designed it with an emphasis on portability, leading to the Zenbook S 16 coming in at 1.1 cm thick, and weighting 1.5 kg. That petite design also means ASUS has configured the Ryzen AI 9 HX 370 chip inside rather conservatively: out of the box, the chip runs at a TDP of just 17 Watts.
CPUsPopular Post
Samsung's 128 TB-Class BM1743 Enterprise SSD Displayed at FMS 2024 Samsung had quietly launched its BM1743 enterprise QLC SSD last month with a hefty 61.44 TB SKU. At FMS 2024, the company had the even larger 122.88 TB version of that SSD on display, alongside a few recorded benchmarking sessions. Compared to the previous generation, the BM1743 comes with a 4.1x improvement in I/O performance, improvement in data retention, and a 45% improvement in power efficiency for sequential writes.
The 128 TB-class QLC SSD boasts of sequential read speeds of 7.5 GBps and write speeds of 3 GBps. Random reads come in at 1.6 M IOPS, while 16 KB random writes clock in at 45K IOPS. Based on the quoted random write access granularity, it appears that Samsung is using a 16 KB indirection unit (IU) to optimize flash management. This is similar to the strategy adopted by Solidigm with IUs larger than 4K in their high-capacity SSDs.
A recorded benchmark session on the company's PM9D3a 8-channel Gen 5 SSD was also on display.
The SSD family is being promoted as a mainstream option for datacenters, and boasts of sequential reads up to 12 GBps and writes up to 6.8 GBps. Random reads clock in at 2 M IOPS, and random writes at 400 K IOPS.
Available in multiple form-factors up to 32 TB (M.2 tops out at 2 TB), the drive's firmware includes optional support for flexible data placement (FDP) to help address the write amplification aspect.
The PM1753 is the current enterprise SSD flagship in Samsung's lineup. With support for 16 NAND channels and capacities up to 32 TB, this U.2 / E3.S SSD has advertised sequential read and write speeds of 14.8 GBps and 11 GBps respectively. Random reads and writes for 4 KB accesses are listed at 3.4 M and 600 K IOPS.
Samsung claims a 1.7x performance improvement and a 1.7x power efficiency improvement over the previous generation (PM1743), making this TLC SSD suitable for AI servers.
The 9th Gen. V-NAND wafer was also available for viewing, though photography was prohibited. Mass production of this flash memory began in April 2024.
Storage

Best CPUs for Gaming: July 2024 As the second quarter of 2024 is soon set to unfold, there are many things to be excited about, especially as Computex 2024 has been and gone. We now know that AMD's upcoming Ryzen 9000 series desktop processors using the new Zen 5 cores will be hitting shelves at the end of the month (31st July), and on top of this, AMD also recently slashed pricing on their Zen 4 (Ryzen 8000) processors. Intel still needs to follow suit with their 14th or 13th Gen Core series processors, but right now from a cost standpoint, AMD is in a much better position.
Since the publication of our last guide, the only notable CPU to be launched was Intel's special binned Core i9-14900KS, which not only pushes clock speeds up to 6.2 GHz but is the last processor to feature Intel's iconic Core I series nomenclature. The other big news in the CPU world was from Intel, with a statement issued about pushing users to use the Intel Default Specification on Intel's 14th and 13th Gen processors, which ultimately limits the performance compared to published data. We're still in the process of
While the CPU market has been relatively quiet so far this year, and things are set to pick up once AMD's Zen 5 and Intel's Arrow Lake desktop chips are all launched onto the market, it means today we are working for the same hymn sheet as our previous guide. With AMD's price drops on Ryzen 7000 series processors, much of the guide reflects this as AMD and Intel's performance is neck and neck in many use cases, but cost certainly plays a big factor in selecting a new CPU. As we move into the rest of 2024, the CPU market looks set to see the rise of the 'AI PC,' which is looking set to be something that many companies will focus on by the end of 2024, both on mobile and desktop platforms.
Guides
Silicon Motion Demonstrates Flexible Data Placement on MonTitan Gen 5 Enterprise SSD Platform At FMS 2024, the technological requirements from the storage and memory subsystem took center stage. Both SSD and controller vendors had various demonstrations touting their suitability for different stages of the AI data pipeline - ingestion, preparation, training, checkpointing, and inference. Vendors like Solidigm have different types of SSDs optimized for different stages of the pipeline. At the same time, controller vendors have taken advantage of one of the features introduced recently in the NVM Express standard - Flexible Data Placement (FDP).
FDP involves the host providing information / hints about the areas where the controller could place the incoming write data in order to reduce the write amplification. These hints are generated based on specific block sizes advertised by the device. The feature is completely backwards-compatible, with non-FDP hosts working just as before with FDP-enabled SSDs, and vice-versa.
Silicon Motion's MonTitan Gen 5 Enterprise SSD Platform was announced back in 2022. Since then, Silicon Motion has been touting the flexibility of the platform, allowing its customers to incorporate their own features as part of the customization process. This approach is common in the enterprise space, as we have seen with Marvell's Bravera SC5 SSD controller in the DapuStor SSDs and Microchip's Flashtec controllers in the Longsys FORESEE enterprise SSDs.
At FMS 2024, the company was demonstrating the advantages of flexible data placement by allowing a single QLC SSD based on their MonTitan platform to take part in different stages of the AI data pipeline while maintaining the required quality of service (minimum bandwidth) for each process. The company even has a trademarked name (PerformaShape) for the firmware feature in the controller that allows the isolation of different concurrent SSD accesses (from different stages in the AI data pipeline) to guarantee this QoS. Silicon Motion claims that this scheme will enable its customers to get the maximum write performance possible from QLC SSDs without negatively impacting the performance of other types of accesses.
Silicon Motion and Phison have market leadership in the client SSD controller market with similar approaches. However, their enterprise SSD controller marketing couldn't be more different. While Phison has gone in for a turnkey solution with their Gen 5 SSD platform (to the extent of not adopting the white label route for this generation, and instead opting to get the SSDs qualified with different cloud service providers themselves), Silicon Motion is opting for a different approach. The flexibility and customization possibilities can make platforms like the MonTitan appeal to flash array vendors.
Storage
Silicon Motion Demonstrates Flexible Data Placement on MonTitan Gen 5 Enterprise SSD Platform At FMS 2024, the technological requirements from the storage and memory subsystem took center stage. Both SSD and controller vendors had various demonstrations touting their suitability for different stages of the AI data pipeline - ingestion, preparation, training, checkpointing, and inference. Vendors like Solidigm have different types of SSDs optimized for different stages of the pipeline. At the same time, controller vendors have taken advantage of one of the features introduced recently in the NVM Express standard - Flexible Data Placement (FDP).
FDP involves the host providing information / hints about the areas where the controller could place the incoming write data in order to reduce the write amplification. These hints are generated based on specific block sizes advertised by the device. The feature is completely backwards-compatible, with non-FDP hosts working just as before with FDP-enabled SSDs, and vice-versa.
Silicon Motion's MonTitan Gen 5 Enterprise SSD Platform was announced back in 2022. Since then, Silicon Motion has been touting the flexibility of the platform, allowing its customers to incorporate their own features as part of the customization process. This approach is common in the enterprise space, as we have seen with Marvell's Bravera SC5 SSD controller in the DapuStor SSDs and Microchip's Flashtec controllers in the Longsys FORESEE enterprise SSDs.
At FMS 2024, the company was demonstrating the advantages of flexible data placement by allowing a single QLC SSD based on their MonTitan platform to take part in different stages of the AI data pipeline while maintaining the required quality of service (minimum bandwidth) for each process. The company even has a trademarked name (PerformaShape) for the firmware feature in the controller that allows the isolation of different concurrent SSD accesses (from different stages in the AI data pipeline) to guarantee this QoS. Silicon Motion claims that this scheme will enable its customers to get the maximum write performance possible from QLC SSDs without negatively impacting the performance of other types of accesses.
Silicon Motion and Phison have market leadership in the client SSD controller market with similar approaches. However, their enterprise SSD controller marketing couldn't be more different. While Phison has gone in for a turnkey solution with their Gen 5 SSD platform (to the extent of not adopting the white label route for this generation, and instead opting to get the SSDs qualified with different cloud service providers themselves), Silicon Motion is opting for a different approach. The flexibility and customization possibilities can make platforms like the MonTitan appeal to flash array vendors.
Storage
Search This Blog
OfferNest
Subscribe Us
Most Popular
Samsung's 128 TB-Class BM1743 Enterprise SSD Displayed at FMS 2024 Samsung had quietly launched its BM1743 enterprise QLC SSD last month with a hefty 61.44 TB SKU. At FMS 2024, the company had the even larger 122.88 TB version of that SSD on display, alongside a few recorded benchmarking sessions. Compared to the previous generation, the BM1743 comes with a 4.1x improvement in I/O performance, improvement in data retention, and a 45% improvement in power efficiency for sequential writes.
The 128 TB-class QLC SSD boasts of sequential read speeds of 7.5 GBps and write speeds of 3 GBps. Random reads come in at 1.6 M IOPS, while 16 KB random writes clock in at 45K IOPS. Based on the quoted random write access granularity, it appears that Samsung is using a 16 KB indirection unit (IU) to optimize flash management. This is similar to the strategy adopted by Solidigm with IUs larger than 4K in their high-capacity SSDs.
A recorded benchmark session on the company's PM9D3a 8-channel Gen 5 SSD was also on display.
The SSD family is being promoted as a mainstream option for datacenters, and boasts of sequential reads up to 12 GBps and writes up to 6.8 GBps. Random reads clock in at 2 M IOPS, and random writes at 400 K IOPS.
Available in multiple form-factors up to 32 TB (M.2 tops out at 2 TB), the drive's firmware includes optional support for flexible data placement (FDP) to help address the write amplification aspect.
The PM1753 is the current enterprise SSD flagship in Samsung's lineup. With support for 16 NAND channels and capacities up to 32 TB, this U.2 / E3.S SSD has advertised sequential read and write speeds of 14.8 GBps and 11 GBps respectively. Random reads and writes for 4 KB accesses are listed at 3.4 M and 600 K IOPS.
Samsung claims a 1.7x performance improvement and a 1.7x power efficiency improvement over the previous generation (PM1743), making this TLC SSD suitable for AI servers.
The 9th Gen. V-NAND wafer was also available for viewing, though photography was prohibited. Mass production of this flash memory began in April 2024.
Storage

Best CPUs for Gaming: July 2024 As the second quarter of 2024 is soon set to unfold, there are many things to be excited about, especially as Computex 2024 has been and gone. We now know that AMD's upcoming Ryzen 9000 series desktop processors using the new Zen 5 cores will be hitting shelves at the end of the month (31st July), and on top of this, AMD also recently slashed pricing on their Zen 4 (Ryzen 8000) processors. Intel still needs to follow suit with their 14th or 13th Gen Core series processors, but right now from a cost standpoint, AMD is in a much better position.
Since the publication of our last guide, the only notable CPU to be launched was Intel's special binned Core i9-14900KS, which not only pushes clock speeds up to 6.2 GHz but is the last processor to feature Intel's iconic Core I series nomenclature. The other big news in the CPU world was from Intel, with a statement issued about pushing users to use the Intel Default Specification on Intel's 14th and 13th Gen processors, which ultimately limits the performance compared to published data. We're still in the process of
While the CPU market has been relatively quiet so far this year, and things are set to pick up once AMD's Zen 5 and Intel's Arrow Lake desktop chips are all launched onto the market, it means today we are working for the same hymn sheet as our previous guide. With AMD's price drops on Ryzen 7000 series processors, much of the guide reflects this as AMD and Intel's performance is neck and neck in many use cases, but cost certainly plays a big factor in selecting a new CPU. As we move into the rest of 2024, the CPU market looks set to see the rise of the 'AI PC,' which is looking set to be something that many companies will focus on by the end of 2024, both on mobile and desktop platforms.
Guides
Silicon Motion Demonstrates Flexible Data Placement on MonTitan Gen 5 Enterprise SSD Platform At FMS 2024, the technological requirements from the storage and memory subsystem took center stage. Both SSD and controller vendors had various demonstrations touting their suitability for different stages of the AI data pipeline - ingestion, preparation, training, checkpointing, and inference. Vendors like Solidigm have different types of SSDs optimized for different stages of the pipeline. At the same time, controller vendors have taken advantage of one of the features introduced recently in the NVM Express standard - Flexible Data Placement (FDP).
FDP involves the host providing information / hints about the areas where the controller could place the incoming write data in order to reduce the write amplification. These hints are generated based on specific block sizes advertised by the device. The feature is completely backwards-compatible, with non-FDP hosts working just as before with FDP-enabled SSDs, and vice-versa.
Silicon Motion's MonTitan Gen 5 Enterprise SSD Platform was announced back in 2022. Since then, Silicon Motion has been touting the flexibility of the platform, allowing its customers to incorporate their own features as part of the customization process. This approach is common in the enterprise space, as we have seen with Marvell's Bravera SC5 SSD controller in the DapuStor SSDs and Microchip's Flashtec controllers in the Longsys FORESEE enterprise SSDs.
At FMS 2024, the company was demonstrating the advantages of flexible data placement by allowing a single QLC SSD based on their MonTitan platform to take part in different stages of the AI data pipeline while maintaining the required quality of service (minimum bandwidth) for each process. The company even has a trademarked name (PerformaShape) for the firmware feature in the controller that allows the isolation of different concurrent SSD accesses (from different stages in the AI data pipeline) to guarantee this QoS. Silicon Motion claims that this scheme will enable its customers to get the maximum write performance possible from QLC SSDs without negatively impacting the performance of other types of accesses.
Silicon Motion and Phison have market leadership in the client SSD controller market with similar approaches. However, their enterprise SSD controller marketing couldn't be more different. While Phison has gone in for a turnkey solution with their Gen 5 SSD platform (to the extent of not adopting the white label route for this generation, and instead opting to get the SSDs qualified with different cloud service providers themselves), Silicon Motion is opting for a different approach. The flexibility and customization possibilities can make platforms like the MonTitan appeal to flash array vendors.
Storage
Silicon Motion Demonstrates Flexible Data Placement on MonTitan Gen 5 Enterprise SSD Platform At FMS 2024, the technological requirements from the storage and memory subsystem took center stage. Both SSD and controller vendors had various demonstrations touting their suitability for different stages of the AI data pipeline - ingestion, preparation, training, checkpointing, and inference. Vendors like Solidigm have different types of SSDs optimized for different stages of the pipeline. At the same time, controller vendors have taken advantage of one of the features introduced recently in the NVM Express standard - Flexible Data Placement (FDP).
FDP involves the host providing information / hints about the areas where the controller could place the incoming write data in order to reduce the write amplification. These hints are generated based on specific block sizes advertised by the device. The feature is completely backwards-compatible, with non-FDP hosts working just as before with FDP-enabled SSDs, and vice-versa.
Silicon Motion's MonTitan Gen 5 Enterprise SSD Platform was announced back in 2022. Since then, Silicon Motion has been touting the flexibility of the platform, allowing its customers to incorporate their own features as part of the customization process. This approach is common in the enterprise space, as we have seen with Marvell's Bravera SC5 SSD controller in the DapuStor SSDs and Microchip's Flashtec controllers in the Longsys FORESEE enterprise SSDs.
At FMS 2024, the company was demonstrating the advantages of flexible data placement by allowing a single QLC SSD based on their MonTitan platform to take part in different stages of the AI data pipeline while maintaining the required quality of service (minimum bandwidth) for each process. The company even has a trademarked name (PerformaShape) for the firmware feature in the controller that allows the isolation of different concurrent SSD accesses (from different stages in the AI data pipeline) to guarantee this QoS. Silicon Motion claims that this scheme will enable its customers to get the maximum write performance possible from QLC SSDs without negatively impacting the performance of other types of accesses.
Silicon Motion and Phison have market leadership in the client SSD controller market with similar approaches. However, their enterprise SSD controller marketing couldn't be more different. While Phison has gone in for a turnkey solution with their Gen 5 SSD platform (to the extent of not adopting the white label route for this generation, and instead opting to get the SSDs qualified with different cloud service providers themselves), Silicon Motion is opting for a different approach. The flexibility and customization possibilities can make platforms like the MonTitan appeal to flash array vendors.
Storage
Samsung's 128 TB-Class BM1743 Enterprise SSD Displayed at FMS 2024 Samsung had quietly launched its BM1743 enterprise QLC SSD last month with a hefty 61.44 TB SKU. At FMS 2024, the company had the even larger 122.88 TB version of that SSD on display, alongside a few recorded benchmarking sessions. Compared to the previous generation, the BM1743 comes with a 4.1x improvement in I/O performance, improvement in data retention, and a 45% improvement in power efficiency for sequential writes.
The 128 TB-class QLC SSD boasts of sequential read speeds of 7.5 GBps and write speeds of 3 GBps. Random reads come in at 1.6 M IOPS, while 16 KB random writes clock in at 45K IOPS. Based on the quoted random write access granularity, it appears that Samsung is using a 16 KB indirection unit (IU) to optimize flash management. This is similar to the strategy adopted by Solidigm with IUs larger than 4K in their high-capacity SSDs.
A recorded benchmark session on the company's PM9D3a 8-channel Gen 5 SSD was also on display.
The SSD family is being promoted as a mainstream option for datacenters, and boasts of sequential reads up to 12 GBps and writes up to 6.8 GBps. Random reads clock in at 2 M IOPS, and random writes at 400 K IOPS.
Available in multiple form-factors up to 32 TB (M.2 tops out at 2 TB), the drive's firmware includes optional support for flexible data placement (FDP) to help address the write amplification aspect.
The PM1753 is the current enterprise SSD flagship in Samsung's lineup. With support for 16 NAND channels and capacities up to 32 TB, this U.2 / E3.S SSD has advertised sequential read and write speeds of 14.8 GBps and 11 GBps respectively. Random reads and writes for 4 KB accesses are listed at 3.4 M and 600 K IOPS.
Samsung claims a 1.7x performance improvement and a 1.7x power efficiency improvement over the previous generation (PM1743), making this TLC SSD suitable for AI servers.
The 9th Gen. V-NAND wafer was also available for viewing, though photography was prohibited. Mass production of this flash memory began in April 2024.
Storage
Silicon Motion Demonstrates Flexible Data Placement on MonTitan Gen 5 Enterprise SSD Platform At FMS 2024, the technological requirements from the storage and memory subsystem took center stage. Both SSD and controller vendors had various demonstrations touting their suitability for different stages of the AI data pipeline - ingestion, preparation, training, checkpointing, and inference. Vendors like Solidigm have different types of SSDs optimized for different stages of the pipeline. At the same time, controller vendors have taken advantage of one of the features introduced recently in the NVM Express standard - Flexible Data Placement (FDP).
FDP involves the host providing information / hints about the areas where the controller could place the incoming write data in order to reduce the write amplification. These hints are generated based on specific block sizes advertised by the device. The feature is completely backwards-compatible, with non-FDP hosts working just as before with FDP-enabled SSDs, and vice-versa.
Silicon Motion's MonTitan Gen 5 Enterprise SSD Platform was announced back in 2022. Since then, Silicon Motion has been touting the flexibility of the platform, allowing its customers to incorporate their own features as part of the customization process. This approach is common in the enterprise space, as we have seen with Marvell's Bravera SC5 SSD controller in the DapuStor SSDs and Microchip's Flashtec controllers in the Longsys FORESEE enterprise SSDs.
At FMS 2024, the company was demonstrating the advantages of flexible data placement by allowing a single QLC SSD based on their MonTitan platform to take part in different stages of the AI data pipeline while maintaining the required quality of service (minimum bandwidth) for each process. The company even has a trademarked name (PerformaShape) for the firmware feature in the controller that allows the isolation of different concurrent SSD accesses (from different stages in the AI data pipeline) to guarantee this QoS. Silicon Motion claims that this scheme will enable its customers to get the maximum write performance possible from QLC SSDs without negatively impacting the performance of other types of accesses.
Silicon Motion and Phison have market leadership in the client SSD controller market with similar approaches. However, their enterprise SSD controller marketing couldn't be more different. While Phison has gone in for a turnkey solution with their Gen 5 SSD platform (to the extent of not adopting the white label route for this generation, and instead opting to get the SSDs qualified with different cloud service providers themselves), Silicon Motion is opting for a different approach. The flexibility and customization possibilities can make platforms like the MonTitan appeal to flash array vendors.
Storage
Kioxia Details BiCS 8 NAND at FMS 2024: 218 Layers With Superior Scaling Kioxia's booth at FMS 2024 was a busy one with multiple technology demonstrations keeping visitors occupied. A walk-through of the BiCS 8 manufacturing process was the first to grab my attention. Kioxia and Western Digital announced the sampling of BiCS 8 in March 2023. We had touched briefly upon its CMOS Bonded Array (CBA) scheme in our coverage of Kioxial's 2Tb QLC NAND device and coverage of Western Digital's 128 TB QLC enterprise SSD proof-of-concept demonstration. At Kioxia's booth, we got more insights.
Traditionally, fabrication of flash chips involved placement of the associate logic circuitry (CMOS process) around the periphery of the flash array. The process then moved on to putting the CMOS under the cell array, but the wafer development process was serialized with the CMOS logic getting fabricated first followed by the cell array on top. However, this has some challenges because the cell array requires a high-temperature processing step to ensure higher reliability that can be detrimental to the health of the CMOS logic. Thanks to recent advancements in wafer bonding techniques, the new CBA process allows the CMOS wafer and cell array wafer to be processed independently in parallel and then pieced together, as shown in the models above.
The BiCS 8 3D NAND incorporates 218 layers, compared to 112 layers in BiCS 5 and 162 layers in BiCS 6. The company decided to skip over BiCS 7 (or, rather, it was probably a short-lived generation meant as an internal test vehicle). The generation retains the four-plane charge trap structure of BiCS 6. In its TLC avatar, it is available as a 1 Tbit device. The QLC version is available in two capacities - 1 Tbit and 2 Tbit.
Kioxia also noted that while the number of layers (218) doesn't compare favorably with the latest layer counts from the competition, its lateral scaling / cell shrinkage has enabled it to be competitive in terms of bit density as well as operating speeds (3200 MT/s). For reference, the latest shipping NAND from Micron - the G9 - has 276 layers with a bit density in TLC mode of 21 Gbit/mm2, and operates at up to 3600 MT/s. However, its 232L NAND operates only up to 2400 MT/s and has a bit density of 14.6 Gbit/mm2.
It must be noted that the CBA hybrid bonding process has advantages over the current processes used by other vendors - including Micron's CMOS under array (CuA) and SK hynix's 4D PUC (periphery-under-chip) developed in the late 2010s. It is expected that other NAND vendors will also move eventually to some variant of the hybrid bonding scheme used by Kioxia.
Storage
Rapidus Adds Chip Packaging Services to Plans for $32 Billion 2nm Fab To say that the global foundry market is booming right now would be an understatement. Demand for leading-edge process technologies driven by AI and HPC applications is unprecedented, and with Intel joining the contract chipmaking game, this market segment is once again becoming rather competitive as well. Yet, this is exactly the market segment that Rapidus, a foundry startup backed by the Japanese government and several major Japanese companies, is going to enter in 2027, when its first fab comes online, just a few years from now.
In a fresh update on the status of bringing up the company's first leading-edge fab, Rapidus has revealed that they are intending to get in to the chip packaging game as well. Once complete, the ¥5 trillion ($32 billion) fab will be offering both chip lithography on a 2nm node, as well as packaging services for chips produced within the facility – a notable distinction in an industry where, even if packaging isn't outsourced entirely (OSAT), it's still normally handled at dedicated facilities.
Ultimately, while the company wants to serve the same clients as TSMC, Samsung, and Intel Foundry, the firm plans to do things almost completely differently than its competitors in a bid to speed up chipmaking from finishing design to getting a working chip out of the fab.
"We are very proud of being Japanese," said Henri Richard, general manager and president of Rapidus's subsidiary in the U.S. "[…] I know that some people may be looking at this thinking [that] Japan is known for quality, attention to detail, but not necessarily for speed, or flexibility. But I will tell you that Atsuyoshi Koike (the head of Rapidus) is a very special executive. That is, he has all the quality of Japan, with a lot of American thinking. So he is quite a unique guy, and certainly extraordinarily focused on creating a company that will be extremely flexible and extremely quick on its feet."
2nm Only, At First
Perhaps the most significant difference between Rapidus and traditional foundries is that the company will offer only leading-edge manufacturing technologies to its clients: 2 nm in 2027 (phase 1) and then 1.4 nm in the future (phase 2). This is a stark contrast with other contract fabs, including Intel, which tend to offer their customers a full range of fabrication processes to land more clients and produce more chips. Apparently, Rapidus hopes that that there will be enough Japanese and American chip developers that are inclined to use its 2 nm fabrication process to produce their designs. With that said, the number of chip designers that are using the most advanced production node at any given time is relatively small – limited to large firms who need first-mover advantage and have the margins to justify taking the risk – so it remains to be seen whether Rapidus's business model becomes successful. The company believes it will, since the market of chips made on advanced nodes is growing rapidly.
"Until recently IDC was giving a an estimation of the 2nm and below market as about $80 billion and I think we are going to see soon a revision of the potential to $150 billion," said Richard. "[…] TSMC is the 800 pound gorilla in the space. Samsung is there and Intel is going to enter that space. But the market growth is so significant and the demand is so high, that it does not take a lot of market share for Rapidus to be successful. One of the things that gives me great comfort is that when I talk to our EDA partners, when I talk to our potential clients, it is obvious that the entire industry is looking for alternative supply from a fully independent foundry. There is a place for Samsung in this industry, there is a place for Intel in this industry, the industry is currently owned by TSMC. But another totally independent foundry is more than welcome by all of the ecosystem partners and by the customers. So, I feel really, really good about Rapidus's positioning."
Speaking of advanced process technologies, it is notable that Rapidus does not plan to use ASML's High-NA Twinscan EXE lithography scanners for 2 nm production. Instead, Rapidus is sticking to ASML's proven Low-NA scanners, which will reduce costs of Rapidus's fab, though it will entail usage of EUV double patterning, which brings up costs and lengthens the production cycle in other ways. Even with those trade-offs, SemiAnalysis analysts believe that given the cost of High-NA EUV litho tools and halved imaging field, ... Semiconductors
Silicon Motion Demonstrates Flexible Data Placement on MonTitan Gen 5 Enterprise SSD Platform At FMS 2024, the technological requirements from the storage and memory subsystem took center stage. Both SSD and controller vendors had various demonstrations touting their suitability for different stages of the AI data pipeline - ingestion, preparation, training, checkpointing, and inference. Vendors like Solidigm have different types of SSDs optimized for different stages of the pipeline. At the same time, controller vendors have taken advantage of one of the features introduced recently in the NVM Express standard - Flexible Data Placement (FDP).
FDP involves the host providing information / hints about the areas where the controller could place the incoming write data in order to reduce the write amplification. These hints are generated based on specific block sizes advertised by the device. The feature is completely backwards-compatible, with non-FDP hosts working just as before with FDP-enabled SSDs, and vice-versa.
Silicon Motion's MonTitan Gen 5 Enterprise SSD Platform was announced back in 2022. Since then, Silicon Motion has been touting the flexibility of the platform, allowing its customers to incorporate their own features as part of the customization process. This approach is common in the enterprise space, as we have seen with Marvell's Bravera SC5 SSD controller in the DapuStor SSDs and Microchip's Flashtec controllers in the Longsys FORESEE enterprise SSDs.
At FMS 2024, the company was demonstrating the advantages of flexible data placement by allowing a single QLC SSD based on their MonTitan platform to take part in different stages of the AI data pipeline while maintaining the required quality of service (minimum bandwidth) for each process. The company even has a trademarked name (PerformaShape) for the firmware feature in the controller that allows the isolation of different concurrent SSD accesses (from different stages in the AI data pipeline) to guarantee this QoS. Silicon Motion claims that this scheme will enable its customers to get the maximum write performance possible from QLC SSDs without negatively impacting the performance of other types of accesses.
Silicon Motion and Phison have market leadership in the client SSD controller market with similar approaches. However, their enterprise SSD controller marketing couldn't be more different. While Phison has gone in for a turnkey solution with their Gen 5 SSD platform (to the extent of not adopting the white label route for this generation, and instead opting to get the SSDs qualified with different cloud service providers themselves), Silicon Motion is opting for a different approach. The flexibility and customization possibilities can make platforms like the MonTitan appeal to flash array vendors.
Storage
Tags
- https://www.amazon.com/2020-2021-Planner-Academic-Do-Twin-Wire/dp/B083V11TM5?tag=all0ad0-21https://m.media-amazon.com/images/I/41btLRSWksL.jpg
- https://www.amazon.com/Acid-Dreams-Complete-History-Sixties-ebook/dp/B005012G6U?tag=all0ad0-21https://m.media-amazon.com/images/I/51SwQkWyzAL.jpg
- https://www.amazon.com/Adaptive-Charging-Charger-Compatible-EP-TA20JBE/dp/B07NPD5T5H?tag=all0ad0-21https://m.media-amazon.com/images/I/419ZKbzdOwL.jpg
- https://www.amazon.com/Adjustable-Foldable-Portable-Compatible-Smartphones/dp/B0963PBY4C?tag=all0ad0-21https://m.media-amazon.com/images/I/51p4wF13kCL.jpg
- https://www.amazon.com/African-Twisted-Headwraps-Headband-Headscarf/dp/B09FDMKTZP?tag=all0ad0-21https://m.media-amazon.com/images/I/41WGbzL+RkL.jpg
- https://www.amazon.com/AINOPE-Charging-Braided-compatible-MacBook/dp/B094YDZQ1C?tag=all0ad0-21https://m.media-amazon.com/images/I/51ppc0xIVtL.jpg
- https://www.amazon.com/Ambergris-Saints-Madmen-Shriek-Finch/dp/B08GGCSN3S?tag=all0ad0-21https://m.media-amazon.com/images/I/51zgVCTiUiL.jpg
- https://www.amazon.com/Amplim-Hospital-Thermometer-Professional-Thermometer/dp/B0865R5H82?tag=all0ad0-21https://m.media-amazon.com/images/I/31K01H4s6UL.jpg
- https://www.amazon.com/Animal-Gaming-Electronic-Lights-Birthday/dp/B0B2QTLWMS?tag=all0ad0-21https://m.media-amazon.com/images/I/41GY22qHwkL.jpg
- https://www.amazon.com/Animals-Flashcards-Children-Alphabet-cards/dp/9811168881?tag=all0ad0-21https://m.media-amazon.com/images/I/51U2gcSb62L.jpg
- https://www.amazon.com/ANNKIE-Dance-Electronic-Lights-Birthday/dp/B0B74DVQQV?tag=all0ad0-21https://m.media-amazon.com/images/I/51K45aP99DL.jpg
- https://www.amazon.com/Anti-Wrinkle-Silicone-Reusable-D%C3%A9collet%C3%A9-Eliminate/dp/B07FQ3QV1C?tag=all0ad0-21https://m.media-amazon.com/images/I/41RhHEsEi3L.jpg
- https://www.amazon.com/anyloop-Military-Smartwatch-Bluetooth-Waterproof/dp/B0C4P7R6CK?tag=all0ad0-21https://m.media-amazon.com/images/I/41lUAHTmi5L.jpg
- https://www.amazon.com/Aromatherapy-Shower-Steamers-Relaxation-Everything/dp/B08QDKWBWS?tag=all0ad0-21https://m.media-amazon.com/images/I/613KwmLJJ1L.jpg
- https://www.amazon.com/Audible-A-Rose-in-Winter/dp/B09JHTGT14?tag=all0ad0-21https://m.media-amazon.com/images/I/51z1bVj4CxL.jpg
- https://www.amazon.com/Audible-Fall-School-Good-Evil/dp/B0B8SZY3P5?tag=all0ad0-21https://m.media-amazon.com/images/I/51MWO0bOLIL.jpg
- https://www.amazon.com/Audible-Termination-Shock-A-Novel/dp/B09556Y79B?tag=all0ad0-21https://m.media-amazon.com/images/I/51jEsfJXG3S.jpg
- https://www.amazon.com/Automatic-Toddlers-Operated-Batteries-Birthday/dp/B0BZH34G2G?tag=all0ad0-21https://m.media-amazon.com/images/I/51PQaTAouaL.jpg
- https://www.amazon.com/AWGOU-Baby-Wipes-Dispenser-Large-Capacity/dp/B0BS3K9BFV?tag=all0ad0-21https://m.media-amazon.com/images/I/41emlsr6WnL.jpg
- https://www.amazon.com/AYAO-Blades-8-Inch-12TPI-2-Pack/dp/B0C9C1VB3D?tag=all0ad0-21https://m.media-amazon.com/images/I/41jMumgfJ4L.jpg
- https://www.amazon.com/Backless-Sleeve-Ribbed-Fitted-Shirts/dp/B0B68KPGP8?tag=all0ad0-21https://m.media-amazon.com/images/I/41vB0uLnuzL.jpg
- https://www.amazon.com/BCHWAY-Stuffed-Storage-Beanbag-Organizer/dp/B09WR2KPPG?tag=all0ad0-21https://m.media-amazon.com/images/I/41GBr+1tEBL.jpg
- https://www.amazon.com/beeprt-Bluetooth-Shipping-Label-Printer/dp/B0BK93ZSNC?tag=all0ad0-21https://m.media-amazon.com/images/I/41Ufm05KrJL.jpg
- https://www.amazon.com/Benewid-Creami-Pints-Lids-Containers/dp/B0C85Q44N6?tag=all0ad0-21https://m.media-amazon.com/images/I/41bFv6o0xjL.jpg
- https://www.amazon.com/BIG-TEETH-Magnetic-Microfiber-5-Piece/dp/B0BRXBM2T9?tag=all0ad0-21https://m.media-amazon.com/images/I/51BCt4B8jDL.jpg
- https://www.amazon.com/Blackbeard-Americas-Most-Notorious-Pirate/dp/B086N4X4SG?tag=all0ad0-21https://m.media-amazon.com/images/I/51fqeuICW+L.jpg
- https://www.amazon.com/Blaster-Automatic-Toddlers-Christmas-Birthday/dp/B0CCV9RDM5?tag=all0ad0-21https://m.media-amazon.com/images/I/51j8FkZtBiL.jpg
- https://www.amazon.com/Bloodline-Jess-Lourey/dp/1542016312?tag=all0ad0-21https://m.media-amazon.com/images/I/51KLqBsOIbL.jpg
- https://www.amazon.com/Bracelet-Stainless-Zirconium-Ceramic-Statement/dp/B0B2CQR5YW?tag=all0ad0-21https://m.media-amazon.com/images/I/41iUmnfsAmL.jpg
- https://www.amazon.com/Bride-Shadow-King-Book/dp/B0B75RL7DX?tag=all0ad0-21https://m.media-amazon.com/images/I/51LyIt-n5+L.jpg
- https://www.amazon.com/Bright-Empires-House-Spirit-Shadow/dp/B08T4VG1S2?tag=all0ad0-21https://m.media-amazon.com/images/I/61-JxjVNClL.jpg
- https://www.amazon.com/BRIGHTWORLD-Stuffers-Upgrade-5-9inch-Birthday/dp/B0B6RBCYZ7?tag=all0ad0-21https://m.media-amazon.com/images/I/61pQaIf3NVL.jpg
- https://www.amazon.com/Bunfly-Clipper-Grooming-Suction-Capacity/dp/B0C6PMSY3Z?tag=all0ad0-21https://m.media-amazon.com/images/I/51ig7m1g9OL.jpg
- https://www.amazon.com/C412H-Spring-Wound-Commercial-12-Hour-Automatic/dp/B00CTW2LYA?tag=all0ad0-21https://m.media-amazon.com/images/I/41QNVA+3MRL.jpg
- https://www.amazon.com/Cardone-Select-84-832-Ignition-Distributor/dp/B000CFFAYY?tag=all0ad0-21https://m.media-amazon.com/images/I/414iGfzryML.jpg
- https://www.amazon.com/ceiba-tree-Graduation-Envelopes-Classroom/dp/B0BQQKSLFK?tag=all0ad0-21https://m.media-amazon.com/images/I/51ZOS4YOvzL.jpg
- https://www.amazon.com/CellElection-Elastic-Ponytail-Holders-Straight/dp/B09TFDLR85?tag=all0ad0-21https://m.media-amazon.com/images/I/514QbooGKKL.jpg
- https://www.amazon.com/Certified-Charger-Charging-Braveridge-Lightning/dp/B0C1VKRXN1?tag=all0ad0-21https://m.media-amazon.com/images/I/41XG+lopk8L.jpg
- https://www.amazon.com/Certified%E3%80%91-Charger-Fasting-Charging-Compatible/dp/B0C489SXGB?tag=all0ad0-21https://m.media-amazon.com/images/I/41dNzZS3BML.jpg
- https://www.amazon.com/Charger-Certified-Lightning-Charging-Compatible/dp/B0C4L9S7QH?tag=all0ad0-21https://m.media-amazon.com/images/I/514iP4Fy28L.jpg
- https://www.amazon.com/Chicken-Shredder-Ergonomic-Anti-Slip-Dishwasher/dp/B0C5R1KZP6?tag=all0ad0-21https://m.media-amazon.com/images/I/61cx6f737WL.jpg
- https://www.amazon.com/Christmas-Decorations-PHITRIC-Sparkling-Fireplace/dp/B0B7WNC93J?tag=all0ad0-21https://m.media-amazon.com/images/I/51Gv07W+JCL.jpg
- https://www.amazon.com/Christmas-Snowflake-Stamping-Manicure-Designer/dp/B09L4SV5YY?tag=all0ad0-21https://m.media-amazon.com/images/I/51TQJxPWLrL.jpg
- https://www.amazon.com/Cleaning-Bathroom-Crevice-Bristle-Multifunctional/dp/B0CDBK4C9T?tag=all0ad0-21https://m.media-amazon.com/images/I/415dsUeaDmL.jpg
- https://www.amazon.com/Clinic-Crohns-Disease-Ulcerative-Colitis-ebook/dp/B09ZBLJLFL?tag=all0ad0-21https://m.media-amazon.com/images/I/41f5FHJle+L.jpg
- https://www.amazon.com/Coasters-Absorbent-Ceramic-Coaster-Housewarming/dp/B09ZKJRSLH?tag=all0ad0-21https://m.media-amazon.com/images/I/51POqbEgyOL.jpg
- https://www.amazon.com/CoBak-Rotating-Case-iPad-Generation/dp/B0BBR8MFHM?tag=all0ad0-21https://m.media-amazon.com/images/I/516NR1N0QKL.jpg
- https://www.amazon.com/COLORFULLEAF-Bamboo-Underwear-Breathable-Trunks/dp/B0B9BX5S9L?tag=all0ad0-21https://m.media-amazon.com/images/I/31MYPhHHapL.jpg
- https://www.amazon.com/Comforter-Paisley-Microfiber-Bohemian-Pillowcases/dp/B0BZP1SC6F?tag=all0ad0-21https://m.media-amazon.com/images/I/51KkoN3AgNL.jpg
- https://www.amazon.com/Compressed-Cordless-Electric-Brushless-Portable/dp/B0BBR1XHLS?tag=all0ad0-21https://m.media-amazon.com/images/I/41dJ2sJpGjL.jpg
- https://www.amazon.com/Cordking-14-Protectors-Shockproof-Microfiber/dp/B0B6GKRCGM?tag=all0ad0-21https://m.media-amazon.com/images/I/41tXMeWi5FL.jpg
- https://www.amazon.com/Cordless-High-Speed-Brushless-Lightweight-Cleaners/dp/B0CGL8NBM8?tag=all0ad0-21https://m.media-amazon.com/images/I/41NfsXSEnLL.jpg
- https://www.amazon.com/Cordless-Straightening-Travel-Wireless-Straightener/dp/B0CJ2HQL3H?tag=all0ad0-21https://m.media-amazon.com/images/I/31wTmdUZyuL.jpg
- https://www.amazon.com/Corrector-Clavicle-Adjustable-Straightener-Providing/dp/B07L41CV8B?tag=all0ad0-21https://m.media-amazon.com/images/I/41B0xbK2kRL.jpg
- https://www.amazon.com/Court-Wizard-Terry-Mancour-audiobook/dp/B07PC2RQSC?tag=all0ad0-21https://m.media-amazon.com/images/I/512jFQbt6JL.jpg
- https://www.amazon.com/Cozivwaiy-Platform-Sandals-Studded-Evening/dp/B0BM43W7VF?tag=all0ad0-21https://m.media-amazon.com/images/I/41+RFM1gP7L.jpg
- https://www.amazon.com/Crenova-Magnetic-Construction-Preschool-Educational/dp/B0CC1RZ2BJ?tag=all0ad0-21https://m.media-amazon.com/images/I/51lJxAlaL3L.jpg
- https://www.amazon.com/Dan-Darci-Marbling-Paint-Kids/dp/B08CLVVJ8C?tag=all0ad0-21https://m.media-amazon.com/images/I/61nDIOC0B0L.jpg
- https://www.amazon.com/Dash-Cam-Front-BOOGIIO-Dashboard/dp/B08LZJ8GMH?tag=all0ad0-21https://m.media-amazon.com/images/I/41B3QK42N1L.jpg
- https://www.amazon.com/Democracy-America-What-Wrong-About-ebook/dp/B0867TRV52?tag=all0ad0-21https://m.media-amazon.com/images/I/4129LSadlmL.jpg
- https://www.amazon.com/Detailing-Attachment-Scrubber-Cleaning-Upholstery/dp/B07WGKQVN7?tag=all0ad0-21https://m.media-amazon.com/images/I/41K75BhGaML.jpg
- https://www.amazon.com/Diameter-Hydrophilic-Filtration-Non-sterile-COBETTER/dp/B0B7BB3L1R?tag=all0ad0-21https://m.media-amazon.com/images/I/31KD4E7TW5L.jpg
- https://www.amazon.com/Diamond-Organizer-Jewelry-Storage-Diamonds/dp/B08JLVSZ15?tag=all0ad0-21https://m.media-amazon.com/images/I/514Z+bbZfQL.jpg
- https://www.amazon.com/Diamond-Painting-Diamonds-12x16inch-30%C3%9740cm/dp/B09X1CQJHX?tag=all0ad0-21https://m.media-amazon.com/images/I/51xEpqCkI-L.jpg
- https://www.amazon.com/didforu-Monocular-Telescope-Monoscope-Binocular/dp/B0C3757D5G?tag=all0ad0-21https://m.media-amazon.com/images/I/512qer0p1oL.jpg
- https://www.amazon.com/Dinkhiiro-Outdoor-Pickleball-Balls-Pickle-Ball-Accessories-Pickleball/dp/B0BNQ8HM76?tag=all0ad0-21https://m.media-amazon.com/images/I/41ni+GPR71L.jpg
- https://www.amazon.com/Distant-Horizon-Backyard-Starship-Book/dp/B0BDP9RPQL?tag=all0ad0-21https://m.media-amazon.com/images/I/512FYS+c9wL.jpg
- https://www.amazon.com/Dorman-1650134-Chevrolet-Driver-Assembly/dp/B00JW1XGDG?tag=all0ad0-21https://m.media-amazon.com/images/I/51p-ja2Vc9L.jpg
- https://www.amazon.com/DosTutu-Mermaid-Costume-Pageant-Birthday/dp/B09NJK6K9M?tag=all0ad0-21https://m.media-amazon.com/images/I/51pVYQBZKJL.jpg
- https://www.amazon.com/dp/B09GFWPXWH?tag=all0ad0-21https://m.media-amazon.com/images/I/51xO7ZL-sVL.jpg
- https://www.amazon.com/DREAMS-VISIONS-Jesus-Awakening-Muslim-ebook/dp/B0078FAA3M?tag=all0ad0-21https://m.media-amazon.com/images/I/51BKVftuXDL.jpg
- https://www.amazon.com/DSJUGGLING-Transparent-Two-Tone-Juggling-Beginners/dp/B09WHRZCFF?tag=all0ad0-21https://m.media-amazon.com/images/I/419NOeSGijL.jpg
- https://www.amazon.com/Empire-of-Storms-Sarah-J-Maas-audiobook/dp/B01KIQV5EU?tag=all0ad0-21https://m.media-amazon.com/images/I/51EMceUgxFL.jpg
- https://www.amazon.com/Eniucow-Montessori-Permanent-Traction-Toddlers/dp/B0B7CZ9KGN?tag=all0ad0-21https://m.media-amazon.com/images/I/31bJyZYqhJL.jpg
- https://www.amazon.com/Eslazoer-insulated-neoprene-reusable-activity/dp/B0BKSMXVN8?tag=all0ad0-21https://m.media-amazon.com/images/I/41kTXH2JxBL.jpg
- https://www.amazon.com/Everyday-Solutions-Mug-Tree-Polished/dp/B0B4T6NCML?tag=all0ad0-21https://m.media-amazon.com/images/I/31-7RTd1fUL.jpg
- https://www.amazon.com/Extender-Universal-Rotatable-Extension-Attachment/dp/B0C4YLVH3D?tag=all0ad0-21https://m.media-amazon.com/images/I/41+YysChcFL.jpg
- https://www.amazon.com/Eyelash-Extension-Cleanser-BREYLEE-Shampoo/dp/B08RJFTFN4?tag=all0ad0-21https://m.media-amazon.com/images/I/51UncwwSzwL.jpg
- https://www.amazon.com/Fatal-Discord-Michael-Massing-audiobook/dp/B078YDCMBD?tag=all0ad0-21https://m.media-amazon.com/images/I/51AJdROll+L.jpg
- https://www.amazon.com/Faucet-Sprayer-Attachment-Replacement-included/dp/B0BCFMT7WY?tag=all0ad0-21https://m.media-amazon.com/images/I/31wZDbk-bYL.jpg
- https://www.amazon.com/Feeling-Good-David-D-Burns-audiobook/dp/B01N9TCVLD?tag=all0ad0-21https://m.media-amazon.com/images/I/51ixV6lf9AL.jpg
- https://www.amazon.com/FeelinGirl-Waitsted-Shapewear-Control-Lifting/dp/B0CBK29G76?tag=all0ad0-21https://m.media-amazon.com/images/I/31Cl6qaK0HL.jpg
- https://www.amazon.com/Fenceguru-Decorative-Rustproof-Barrier-Landscape/dp/B0BZ91ZPHF?tag=all0ad0-21https://m.media-amazon.com/images/I/519kGS3sjxL.jpg
- https://www.amazon.com/Fernco-PQC-105-Flexible-Reusable-Plastic/dp/B00CFVNCCK?tag=all0ad0-21https://m.media-amazon.com/images/I/21xcHMaS37L.jpg
- https://www.amazon.com/Floating-Shelves-Bathroom-Bedroom-Kitchen/dp/B0CF8J497J?tag=all0ad0-21https://m.media-amazon.com/images/I/51cT9HpSh4L.jpg
- https://www.amazon.com/Forehead-Thermometer-Infrared-Eligible-Indicator/dp/B0B4ZD6K43?tag=all0ad0-21https://m.media-amazon.com/images/I/31J97vQVUHL.jpg
- https://www.amazon.com/FRGROW-Lights-Spectrum-Function-Gooseneck/dp/B0CC4P13L7?tag=all0ad0-21https://m.media-amazon.com/images/I/51UXtap-56L.jpg
- https://www.amazon.com/Funrous-Mattress-Lifter-Helper-Stainless/dp/B09WMZPM1N?tag=all0ad0-21https://m.media-amazon.com/images/I/31Vg6rJibzL.jpg
- https://www.amazon.com/GAOY-Glassy-Foundation-Combination-Polish/dp/B0BD4MMFVM?tag=all0ad0-21https://m.media-amazon.com/images/I/414wIShbm+L.jpg
- https://www.amazon.com/Gay-Pride-Rainbow-Heart-Silicone/dp/B01J8E5NUA?tag=all0ad0-21https://m.media-amazon.com/images/I/31TtNjUl3uL.jpg
- https://www.amazon.com/Gerod-Compatible-Replacement-Cushions-Headphones/dp/B09BPV34ZB?tag=all0ad0-21https://m.media-amazon.com/images/I/41cXXPmWNoL.jpg
- https://www.amazon.com/GetKen-Dispenser-Rechargeable-Portable-Automatic/dp/B0C4T26LK4?tag=all0ad0-21https://m.media-amazon.com/images/I/41v5jE7AsIL.jpg
- https://www.amazon.com/Gifts-Girls-birthday-Toys-Duplication/dp/B0B6FY328P?tag=all0ad0-21https://m.media-amazon.com/images/I/51mMmkuwdfL.jpg
- https://www.amazon.com/Girls-Charm-Bracelet-Making-Kit/dp/B0CFCC8HBZ?tag=all0ad0-21https://m.media-amazon.com/images/I/81-SB1q4h1L.jpg
- https://www.amazon.com/Girls-Charm-Bracelet-Making-Kit/dp/B0CFF3SLJT?tag=all0ad0-21https://m.media-amazon.com/images/I/81kJ83iM+IL.jpg
- https://www.amazon.com/GloFX-Blue-Rave-Bedroom-Decor/dp/B0B7ZXG6PS?tag=all0ad0-21https://m.media-amazon.com/images/I/41iPdpfs1DL.jpg
- https://www.amazon.com/GMSOL-Diamond-Necklaces-Necklace-Layered/dp/B0BXKY3XW9?tag=all0ad0-21https://m.media-amazon.com/images/I/21iQgpW3i4L.jpg
- https://www.amazon.com/Greenland-Home-GL-THROWSH-Shangri-La-Throw/dp/B017U6U8JO?tag=all0ad0-21https://m.media-amazon.com/images/I/61VISLraXWL.jpg
- https://www.amazon.com/Gyierwe-High-Pressure-Stainless-Adjustable-Filtration/dp/B0C5RHCSN8?tag=all0ad0-21https://m.media-amazon.com/images/I/51RZ3tTLzyL.jpg
- https://www.amazon.com/Halloween-Decorations-Indoor-DECSPAS-Haunted/dp/B0C6JPZ6K5?tag=all0ad0-21https://m.media-amazon.com/images/I/51zSmWVx7HL.jpg
- https://www.amazon.com/HawSkgFub-Curtains-Farmhouse-Seasonal-Bathroom/dp/B0BVLTJR4P?tag=all0ad0-21https://m.media-amazon.com/images/I/412k-TN9yzL.jpg
- https://www.amazon.com/Helping-Soldering-Hand-Base-Microscope/dp/B0BBR46ZQ9?tag=all0ad0-21https://m.media-amazon.com/images/I/41IZoepkAkL.jpg
- https://www.amazon.com/Her-Soul-Take-Souls-Trilogy/dp/B0BDT2M2QZ?tag=all0ad0-21https://m.media-amazon.com/images/I/51Z1AUkTytL.jpg
- https://www.amazon.com/HISANDUK-Pendant-Fixtures-Kitchen-Adjustable/dp/B0B76G6VCT?tag=all0ad0-21https://m.media-amazon.com/images/I/41SzQX+tAeL.jpg
- https://www.amazon.com/Homeleo-Operated-Christmas-Strawberry-Decorations/dp/B07WTVGTWX?tag=all0ad0-21https://m.media-amazon.com/images/I/51+CNn9QowL.jpg
- https://www.amazon.com/House-of-Impossible-Beauties-audiobook/dp/B077VQ68HH?tag=all0ad0-21https://m.media-amazon.com/images/I/51VFkDIrDsL.jpg
- https://www.amazon.com/HOUSE-Organizer-Upgraded-Undersink-Organizers/dp/B0BY8XZK71?tag=all0ad0-21https://m.media-amazon.com/images/I/510FKKVDhpL.jpg
- https://www.amazon.com/House-Witch-Humorous-Romantic-Fantasy/dp/B0BLJ7CQKK?tag=all0ad0-21https://m.media-amazon.com/images/I/61+JJSw9jZL.jpg
- https://www.amazon.com/HR-Quadcopter-Beginners-Altitude-Batteries/dp/B08L8YFT4S?tag=all0ad0-21https://m.media-amazon.com/images/I/41pf-DNDj5L.jpg
- https://www.amazon.com/Humble-Chic-Wall-Art-Prints/dp/B07QL3GTX4?tag=all0ad0-21https://m.media-amazon.com/images/I/31QO1OLNDGL.jpg
- https://www.amazon.com/Huyerdo-Corduroy-Cosmetic-Aesthetic-Organizer/dp/B0C1YXPX5M?tag=all0ad0-21https://m.media-amazon.com/images/I/51Es7IjWzjL.jpg
- https://www.amazon.com/I-Invited-Her-In-Adele-Parks-audiobook/dp/B07JZGFFHY?tag=all0ad0-21https://m.media-amazon.com/images/I/51ak3gyHziL.jpg
- https://www.amazon.com/In1docom-Peanut-Massage-Massager-Lacrosse/dp/B0CB4S2JRX?tag=all0ad0-21https://m.media-amazon.com/images/I/41sBnhqhZzL.jpg
- https://www.amazon.com/INeedIt-D101-Portable-Wireless-Organization/dp/B0BCKV8B81?tag=all0ad0-21https://m.media-amazon.com/images/I/21OGF1G7x9L.jpg
- https://www.amazon.com/Inflatable-Ground-Dustproof-Rainproof-Waterproof/dp/B0CB8B4PKX?tag=all0ad0-21https://m.media-amazon.com/images/I/51o0yuVrjPL.jpg
- https://www.amazon.com/Insane-Labz-Bitartrate-AMPiberry-Endurance/dp/B07V6JCWJG?tag=all0ad0-21https://m.media-amazon.com/images/I/51GZtu2lUZL.jpg
- https://www.amazon.com/Island-Queen-A-Novel/dp/B08MLPY619?tag=all0ad0-21https://m.media-amazon.com/images/I/51snO62ltvL.jpg
- https://www.amazon.com/J-hong-Toddlers-Learning-Montessori-Christmas/dp/B0C4LK67Q5?tag=all0ad0-21https://m.media-amazon.com/images/I/51q4mMYfoLL.jpg
- https://www.amazon.com/jalz-Wooden-Spoons-Cooking-3-Piece/dp/B07DZKTC9B?tag=all0ad0-21https://m.media-amazon.com/images/I/416iXJ1B8PL.jpg
- https://www.amazon.com/JENN-ARDOR-Fashion-Sneakers-Comfortable/dp/B08N16X7HR?tag=all0ad0-21https://m.media-amazon.com/images/I/41y+m0CTBeS.jpg
- https://www.amazon.com/John-Sterling-Sports-7-Ball-Capacity/dp/B01DWSH1I0?tag=all0ad0-21https://m.media-amazon.com/images/I/31-O3z3v+XL.jpg
- https://www.amazon.com/Jorpet-Elevated-Adjustable-Non-Slip-Stainless/dp/B0C3YRH31J?tag=all0ad0-21https://m.media-amazon.com/images/I/41+P1DIyA0L.jpg
- https://www.amazon.com/JOYMODE-women-workout-clothes-Legging/dp/B08766FN91?tag=all0ad0-21https://m.media-amazon.com/images/I/31DoD7LD8EL.jpg
- https://www.amazon.com/Kettlebell-Whiskey-Shaped-Silicone-Melting/dp/B0C5NBXHDF?tag=all0ad0-21https://m.media-amazon.com/images/I/41XwetcdbXL.jpg
- https://www.amazon.com/Kingdom-Come-Backyard-Starship-Book/dp/B0BKBRDCV2?tag=all0ad0-21https://m.media-amazon.com/images/I/51DX-OPQv6L.jpg
- https://www.amazon.com/Kitchen-BAYZZ-Cushioned-Non-Slip-Waterproof/dp/B095GZYG7Z?tag=all0ad0-21https://m.media-amazon.com/images/I/41-vM6JlCeL.jpg
- https://www.amazon.com/KOIOS-Immersion-Multifunctional-Stainless-Titanium/dp/B076GW89V9?tag=all0ad0-21https://m.media-amazon.com/images/I/41YrmEtdu0L.jpg
- https://www.amazon.com/Lady-Orc-Sworn-Book/dp/B0B4BB9B21?tag=all0ad0-21https://m.media-amazon.com/images/I/51VsjpQ+WoL.jpg
- https://www.amazon.com/Large-Multipurpose-Waterproof-Picnic-Shopping/dp/B0CCS1HSMK?tag=all0ad0-21https://m.media-amazon.com/images/I/410kS6OJJHL.jpg
- https://www.amazon.com/Large-Multipurpose-Waterproof-Picnic-Shopping/dp/B0CF58TZ9J?tag=all0ad0-21https://m.media-amazon.com/images/I/410kS6OJJHL.jpg
- https://www.amazon.com/Lay-My-Heart-Angela-Pneuman-ebook/dp/B00FJ5EQ0Q?tag=all0ad0-21https://m.media-amazon.com/images/I/419DBRj4HuL.jpg
- https://www.amazon.com/LeadDock-Ice-Cube-Tray-Lid/dp/B0CB6TN9DY?tag=all0ad0-21https://m.media-amazon.com/images/I/51WpROdbWEL.jpg
- https://www.amazon.com/Learning-Educational-Preschool-Developmental-Montessori/dp/B0BY2HBQLS?tag=all0ad0-21https://m.media-amazon.com/images/I/510R2-67PbL.jpg
- https://www.amazon.com/LEDKINGDOMUS-inches-Driving-Compatible-Pickup/dp/B09176936Z?tag=all0ad0-21https://m.media-amazon.com/images/I/416I+aay3RL.jpg
- https://www.amazon.com/Legend-Randidly-Ghosthound-LitRPG-Adventure/dp/B09CR88G8L?tag=all0ad0-21https://m.media-amazon.com/images/I/51cte+pTRVL.jpg
- https://www.amazon.com/Legend-Randidly-Ghosthound-LitRPG-Adventure/dp/B09NB32VS5?tag=all0ad0-21https://m.media-amazon.com/images/I/51HquIJf4EL.jpg
- https://www.amazon.com/Legend-Randidly-Ghosthound-LitRPG-Adventure/dp/B09WTLH4Z9?tag=all0ad0-21https://m.media-amazon.com/images/I/61j-pJq9blL.jpg
- https://www.amazon.com/LENRUE-Computer-Speakers-Desktop-AUX_Black/dp/B0BRFN13S9?tag=all0ad0-21https://m.media-amazon.com/images/I/41XeSj+qShL.jpg
- https://www.amazon.com/LIANTRAL-Firewood-Outdoor-Upgrade-Fireplace/dp/B0BKSVRW4N?tag=all0ad0-21https://m.media-amazon.com/images/I/51Y9mIZmocL.jpg
- https://www.amazon.com/Lilys-White-Lace-Carolyn-Brown-ebook/dp/B00DTTW5UW?tag=all0ad0-21https://m.media-amazon.com/images/I/51iPZWUaUQL.jpg
- https://www.amazon.com/LISEN-Magnetic-Install-Friendly-Smartphones/dp/B07YRKDF4P?tag=all0ad0-21https://m.media-amazon.com/images/I/51tMoOMiRzL.jpg
- https://www.amazon.com/LJIOEZZI-Balaclava-Weather-Snowboarding-Motorcycling/dp/B0BHVNYM8Z?tag=all0ad0-21https://m.media-amazon.com/images/I/31YRjxzYi8L.jpg
- https://www.amazon.com/LOXP-2C-CAR-Sun-Shade-Umbrella-Medium/dp/B0BR7WLLY4?tag=all0ad0-21https://m.media-amazon.com/images/I/41vWPHUEsJL.jpg
- https://www.amazon.com/LUENX-Trendy-Oversized-Aviator-Sunglasses/dp/B09CMB5D7N?tag=all0ad0-21https://m.media-amazon.com/images/I/41uZsi7kskL.jpg
- https://www.amazon.com/MAGEFY-Eyelashes-Natural-Handmade-Reusable/dp/B0956V789H?tag=all0ad0-21https://m.media-amazon.com/images/I/51UgJTxfm2S.jpg
- https://www.amazon.com/Magnetic-Birthday-Building-Preschool-Montessori/dp/B0BWWPC5MR?tag=all0ad0-21https://m.media-amazon.com/images/I/61UuS8o90ZL.jpg
- https://www.amazon.com/Makartt-Extension-Glitter-Trendy-Builder/dp/B096VQW7NF?tag=all0ad0-21https://m.media-amazon.com/images/I/31hUzSIu6gL.jpg
- https://www.amazon.com/Makeup-Brush-Holder-Travel-Essentials/dp/B0C7G5YXRZ?tag=all0ad0-21https://m.media-amazon.com/images/I/31od+KNxUkL.jpg
- https://www.amazon.com/MaraFansie-Housewarming-Birthday-Anniversary-Graduation/dp/B0BS416GJ3?tag=all0ad0-21https://m.media-amazon.com/images/I/51QjF6NaQ+L.jpg
- https://www.amazon.com/MAREE-Face-Moisturizer-Anti-Wrinkle-Hyaluronic/dp/B0C3LXWJJ7?tag=all0ad0-21https://m.media-amazon.com/images/I/512NgLTHbTL.jpg
- https://www.amazon.com/Matter-Black-Lives-Writing-Yorker/dp/B08TP4YC6S?tag=all0ad0-21https://m.media-amazon.com/images/I/513aBwlCG-L.jpg
- https://www.amazon.com/Mavericks-Craig-Alanson-audiobook/dp/B07GH5ZJ3N?tag=all0ad0-21https://m.media-amazon.com/images/I/51OW+MpwHYL.jpg
- https://www.amazon.com/McAfee-Protection-Exclusive-Monitoring-Subscription/dp/B0BB2N69J8?tag=all0ad0-21https://m.media-amazon.com/images/I/510kxZvrlKL.jpg
- https://www.amazon.com/McAfee-Protection-Unlimited-Device-Download/dp/B07BFRVMMN?tag=all0ad0-21https://m.media-amazon.com/images/I/51qNb5s7JzL.jpg
- https://www.amazon.com/McAfee-Total-Protection-Devices-Subscription/dp/B07K98XDX8?tag=all0ad0-21https://m.media-amazon.com/images/I/51P0zntKKaL.jpg
- https://www.amazon.com/McAfee-Total-Protection-Devices-Subscription/dp/B07K995RWG?tag=all0ad0-21https://m.media-amazon.com/images/I/51hk1owA-eL.jpg
- https://www.amazon.com/McClusky-Battle-Midway-David-Rigby-ebook/dp/B07NJCKM5P?tag=all0ad0-21https://m.media-amazon.com/images/I/41wKgBrbEhL.jpg
- https://www.amazon.com/Meat-Thermometer-Digital-Grilling-Cooking/dp/B0BQ782XNW?tag=all0ad0-21https://m.media-amazon.com/images/I/51cOJyK7rHL.jpg
- https://www.amazon.com/Missing-Molly-Natalie-Barelli-audiobook/dp/B07N7HZ9XJ?tag=all0ad0-21https://m.media-amazon.com/images/I/41G2D08UIgL.jpg
- https://www.amazon.com/Mondays-Not-Coming-audiobook/dp/B07B7897X8?tag=all0ad0-21https://m.media-amazon.com/images/I/51BRoON6IWL.jpg
- https://www.amazon.com/Monster-Wireless-Bluetooth-Headphones-Rotating/dp/B097JZQXXL?tag=all0ad0-21https://m.media-amazon.com/images/I/41RciianoPL.jpg
- https://www.amazon.com/Moolan-Cordless-Portable-Powerful-Rechargeable/dp/B0CB1C743Z?tag=all0ad0-21https://m.media-amazon.com/images/I/41qRyj2A+xL.jpg
- https://www.amazon.com/MORNEEX-Polyester-Bathroom-Waterproof-72X72inches/dp/B0B712Q9QD?tag=all0ad0-21https://m.media-amazon.com/images/I/41ejnaDrS0L.jpg
- https://www.amazon.com/MOYEIKH-Talking-Elderly-Visually-Impaired/dp/B0C4LCMTNN?tag=all0ad0-21https://m.media-amazon.com/images/I/41m7k3YEUXL.jpg
- https://www.amazon.com/Mr-You-Organizer-ModelsStand-Dust-proof-Velvet%EF%BC%8C12L/dp/B082X6BCJG?tag=all0ad0-21https://m.media-amazon.com/images/I/51cRFT9gZCL.jpg
- https://www.amazon.com/MUJERBAY-Massager-Compression-Full-Cover-Fasciitis/dp/B0BWJ4LT32?tag=all0ad0-21https://m.media-amazon.com/images/I/41d7tUceqaL.jpg
- https://www.amazon.com/Musashi-audiobook/dp/B07FXMJCX6?tag=all0ad0-21https://m.media-amazon.com/images/I/515t3Zygd7L.jpg
- https://www.amazon.com/MUSICOZY-Headphones-Bluetooth-Headband-Waterproof/dp/B09NN1MJQS?tag=all0ad0-21https://m.media-amazon.com/images/I/41qxlHs2CTL.jpg
- https://www.amazon.com/My-Dear-Hamilton-audiobook/dp/B077NN1WWF?tag=all0ad0-21https://m.media-amazon.com/images/I/51sBrSA5VfL.jpg
- https://www.amazon.com/NATOLIKE-Pickleball-Lightweight-Fiberglass-Polypropylene/dp/B0BY8JF32S?tag=all0ad0-21https://m.media-amazon.com/images/I/61I+i2U7+sL.jpg
- https://www.amazon.com/Natrol-High-Potency-Antioxidant-Vitamin-Tablets/dp/B08KXGJXR1?tag=all0ad0-21https://m.media-amazon.com/images/I/41y11UVSqkL.jpg
- https://www.amazon.com/Necromancer-Spellmonger-Book-10/dp/B083YVZ8YQ?tag=all0ad0-21https://m.media-amazon.com/images/I/51FELytNyCL.jpg
- https://www.amazon.com/NeoLartes-July-White-Berry-Garlands/dp/B0BWDHKFWV?tag=all0ad0-21https://m.media-amazon.com/images/I/51P3USHQMCL.jpg
- https://www.amazon.com/Neoprene-Dumbbell-Weights-Anti-slip-Anti-roll/dp/B087JDLWLQ?tag=all0ad0-21https://m.media-amazon.com/images/I/31hKC3UgF7L.jpg
- https://www.amazon.com/NEW-Norton-AntiVirus-Plus-Antivirus/dp/B07Q69X7XL?tag=all0ad0-21https://m.media-amazon.com/images/I/51M35ZaPBmL.jpg
- https://www.amazon.com/Nexillumi-LED-Lights-60-75-Inch/dp/B07XBJR7GY?tag=all0ad0-21https://m.media-amazon.com/images/I/519sc2GYDnL.jpg
- https://www.amazon.com/Nicebay-Professional-Dryerwith3-Attachments-Lightweight/dp/B0CBSHRBS6?tag=all0ad0-21https://m.media-amazon.com/images/I/41Og2LDzcML.jpg
- https://www.amazon.com/Night-Sleep-Death-Stars-Novel/dp/B07XY9SKT3?tag=all0ad0-21https://m.media-amazon.com/images/I/51bBRM-4BUL.jpg
- https://www.amazon.com/NuLink-Electric-Inflation-Decoration-110V-120V/dp/B01H2QF6SK?tag=all0ad0-21https://m.media-amazon.com/images/I/41mdv0LnxfL.jpg
- https://www.amazon.com/Nylavee-Computer-Speakers-Soundbar-Connection/dp/B0BZCMM17X?tag=all0ad0-21https://m.media-amazon.com/images/I/41GYynP1rrL.jpg
- https://www.amazon.com/Oakland-Living-Rose-Bird-Bath/dp/B000PAKVJK?tag=all0ad0-21https://m.media-amazon.com/images/I/41MzpuSS3yL.jpg
- https://www.amazon.com/Oasis-033879-001-VersaFiller-Filter-Cartridge/dp/B002WDQGXS?tag=all0ad0-21https://m.media-amazon.com/images/I/41nyJPxi4SL.jpg
- https://www.amazon.com/OBL-Plastic-Durable-Non-deformable-Imitation/dp/B07SKJ946F?tag=all0ad0-21https://m.media-amazon.com/images/I/51Z2NMJGOwL.jpg
- https://www.amazon.com/OCHYIT-Protector-Waterproof-Defender-Analyzer/dp/B0BKL8DWQR?tag=all0ad0-21https://m.media-amazon.com/images/I/41XownI6MdL.jpg
- https://www.amazon.com/Oil-Sprayer-Dispenser-Accessories-Spritzer/dp/B0B93CBCFC?tag=all0ad0-21https://m.media-amazon.com/images/I/51nNMZPYUXL.jpg
- https://www.amazon.com/OKIMO-Wireless-Computer-Ergonomic-Chromebook/dp/B0CC4KLTKM?tag=all0ad0-21https://m.media-amazon.com/images/I/41LJQ8jNxZL.jpg
- https://www.amazon.com/Organizer-Buttonholes-Stretchable-Connectable-Adjustable/dp/B0C22ZMRWC?tag=all0ad0-21https://m.media-amazon.com/images/I/51ql4-4eN8L.jpg
- https://www.amazon.com/Organizer-organizer-Zippers-Blocking-Insert%EF%BC%8C5/dp/B07WMWCBTQ?tag=all0ad0-21https://m.media-amazon.com/images/I/310UEu-zi7L.jpg
- https://www.amazon.com/ORICO-Adapter-External-Converter-Transfer/dp/B0B3MMJ1LB?tag=all0ad0-21https://m.media-amazon.com/images/I/41dfdJx68AL.jpg
- https://www.amazon.com/Original-Certified-Charging-Lightning-Compatible/dp/B0CJDHYYZD?tag=all0ad0-21https://m.media-amazon.com/images/I/41trxkrOxLL.jpg
- https://www.amazon.com/Oupeng-sky-Carabiner-Clip-Ring/dp/B07MSBZ7BZ?tag=all0ad0-21https://m.media-amazon.com/images/I/51Bxk8se22L.jpg
- https://www.amazon.com/Over-Top-Jonathan-Van-Ness-audiobook/dp/B07Q386LM5?tag=all0ad0-21https://m.media-amazon.com/images/I/51rcfpVI5UL.jpg
- https://www.amazon.com/Padfolio-Portfolio-Interview-Document-Organizer/dp/B07VLPS9ZK?tag=all0ad0-21https://m.media-amazon.com/images/I/41CSIOr0ZoL.jpg
- https://www.amazon.com/Pairs-Heavy-Ratchet-Tie-Mount-Crossbar-Easy/dp/B0725Z9LSB?tag=all0ad0-21https://m.media-amazon.com/images/I/41xI-f4Jj9L.jpg
- https://www.amazon.com/Paperwhite-Generation-Signature-Lightweight-Transparent/dp/B0C8B1JJYZ?tag=all0ad0-21https://m.media-amazon.com/images/I/41MpXChQpIL.jpg
- https://www.amazon.com/Paw-Patrol-Collectible-DIE-CAST-Vehicles/dp/B07S6VH6DD?tag=all0ad0-21https://m.media-amazon.com/images/I/41nC9yFe1dL.jpg
- https://www.amazon.com/Peace-nest-Checkered-Checkerboard-Lightweight/dp/B0BX969J3C?tag=all0ad0-21https://m.media-amazon.com/images/I/51D8BO3dasL.jpg
- https://www.amazon.com/Perfect-Run-Book/dp/B09SVMRP12?tag=all0ad0-21https://m.media-amazon.com/images/I/51zkV2RkC2L.jpg
- https://www.amazon.com/Pet-Grooming-Brush-Double-Sided-Blue/dp/B0BRPZY67Z?tag=all0ad0-21https://m.media-amazon.com/images/I/41iA2Z29chL.jpg
- https://www.amazon.com/Pieces-Washed-Reversible-Cooling-Closure/dp/B094FGZ3XD?tag=all0ad0-21https://m.media-amazon.com/images/I/41hX+gmSQvL.jpg
- https://www.amazon.com/PINHEN-Stabilizer-360%C2%B0Rotate-Hands-Free-Compatible/dp/B09N8VL6VT?tag=all0ad0-21https://m.media-amazon.com/images/I/41j3QfO4JLL.jpg
- https://www.amazon.com/Planner-2023-2024-Academic-Calendar-Hardcover/dp/B0BP22KCYV?tag=all0ad0-21https://m.media-amazon.com/images/I/51xfDnKUkSL.jpg
- https://www.amazon.com/Ponytail-hoyuwak-Rhinestone-Accessories-Silver/dp/B0C1GRQNLM?tag=all0ad0-21https://m.media-amazon.com/images/I/51Jl+ePN1vL.jpg
- https://www.amazon.com/Portable-Wireless-Espresso-Machine-Freshly-brewed/dp/B09LCKLYGT?tag=all0ad0-21https://m.media-amazon.com/images/I/21uyv4z55pL.jpg
- https://www.amazon.com/Premom-Quantitative-Ovulation-Predictor-Numerical/dp/B07P7LSW57?tag=all0ad0-21https://m.media-amazon.com/images/I/51dY9dReMhL.jpg
- https://www.amazon.com/Professional-Pedicure-Rosmax-Stainless-Washable/dp/B08TM7TH1N?tag=all0ad0-21https://m.media-amazon.com/images/I/519tcTL-K8L.jpg
- https://www.amazon.com/Projector-Bluetooth-15000Lumens-Portable-Compatible/dp/B0CGXHVB5D?tag=all0ad0-21https://m.media-amazon.com/images/I/414hYl+AJuL.jpg
- https://www.amazon.com/Projector-Control-Bluetooth-Dimmable-Projection/dp/B09F95JS41?tag=all0ad0-21https://m.media-amazon.com/images/I/61GYRolZ-9L.jpg
- https://www.amazon.com/Projector-HOMPOW-Bluetooth-Correction-Compatible/dp/B0BCKV1VHX?tag=all0ad0-21https://m.media-amazon.com/images/I/616j3cS2O9L.jpg
- https://www.amazon.com/Protector-Coverage-Protection-Installation-Specially/dp/B0B87THFLK?tag=all0ad0-21https://m.media-amazon.com/images/I/41tlgaNVLCL.jpg
- https://www.amazon.com/Protectors-Furniture-Scratches-Hardwood-Large/dp/B0CHB4ZR22?tag=all0ad0-21https://m.media-amazon.com/images/I/51UIaW9XlXL.jpg
- https://www.amazon.com/Purifier-Purifiers-VEWIOR-Settings-Ultra-Quiet/dp/B0B41Z7B6H?tag=all0ad0-21https://m.media-amazon.com/images/I/41o0rCSrKcL.jpg
- https://www.amazon.com/Purifiers-Purifier-Aromatherapy-Function-Filtration/dp/B0C5GCPDV2?tag=all0ad0-21https://m.media-amazon.com/images/I/41KvpYD7k5L.jpg
- https://www.amazon.com/QAWDAWM-Conduction-Headphones-Bluetooth-Waterproof/dp/B0CGR1799N?tag=all0ad0-21https://m.media-amazon.com/images/I/41trzwTzdKL.jpg
- https://www.amazon.com/REDESS-Beanie-Women-Winter-Slouchy/dp/B0BZVDHFNJ?tag=all0ad0-21https://m.media-amazon.com/images/I/51hHyl+rkWL.jpg
- https://www.amazon.com/Robot-Vacuum-Mop-Combo-Self-Charging/dp/B0CD3XTMS1?tag=all0ad0-21https://m.media-amazon.com/images/I/518O5sALu1L.jpg
- https://www.amazon.com/RONGPRO-Combination-Carpenter-Zinc-Alloy-Die-Casting/dp/B09GVQRZVK?tag=all0ad0-21https://m.media-amazon.com/images/I/41uHEayHMEL.jpg
- https://www.amazon.com/ROOMLIFE-Chenille-Slipcover-Loveseat-Sectional/dp/B0BJ5T5Z91?tag=all0ad0-21https://m.media-amazon.com/images/I/51VNyhUtziL.jpg
- https://www.amazon.com/Ryan-Rule-York-Ruthless-Book/dp/B0BPJSLNDX?tag=all0ad0-21https://m.media-amazon.com/images/I/51o9mZQpbgL.jpg
- https://www.amazon.com/Sandstorm-Street-Rats-Aramoor-Book/dp/B09QDYGXGT?tag=all0ad0-21https://m.media-amazon.com/images/I/61g7nbsvDiL.jpg
- https://www.amazon.com/Santoku-Knife-Stainless-Ergonomic-Restaurant/dp/B0865TNBKC?tag=all0ad0-21https://m.media-amazon.com/images/I/41bVfVBEhOL.jpg
- https://www.amazon.com/SATC-Woodworking-Carpenters-Gardening-Resistant/dp/B09WYGJJ3F?tag=all0ad0-21https://m.media-amazon.com/images/I/31U+zqjEzNL.jpg
- https://www.amazon.com/Scissors-ULG-Hairdressing-Stainless-Detachable/dp/B09ZTZYDT2?tag=all0ad0-21https://m.media-amazon.com/images/I/315+PnPQhmL.jpg
- https://www.amazon.com/SeaVees-Mens-Standard-Casual-Sneaker/dp/B008TUCU1A?tag=all0ad0-21https://m.media-amazon.com/images/I/31z4PJ-dnQL.jpg
- https://www.amazon.com/Security-Lighting-Waterproof-Outdoor-Basketball/dp/B09GV2B545?tag=all0ad0-21https://m.media-amazon.com/images/I/41Hh9Px9UzL.jpg
- https://www.amazon.com/Shadow-Dark-Queen-Serpentwar-Saga/dp/B07YCT8PKM?tag=all0ad0-21https://m.media-amazon.com/images/I/517+deIbkiL.jpg
- https://www.amazon.com/Shadowplay-Spellmonger-Legacy-Secrets-Book/dp/B09DZ4S8MG?tag=all0ad0-21https://m.media-amazon.com/images/I/51mV-QcOzOL.jpg
- https://www.amazon.com/Shamrocks-Bedroom-Bathroom-Kitchen-Hallway/dp/B07ZV5DSTN?tag=all0ad0-21https://m.media-amazon.com/images/I/51J0KqPk6ML.jpg
- https://www.amazon.com/Silicone-Reusable-AiKanbo-Airtight-Preservation/dp/B09X1LXS9B?tag=all0ad0-21https://m.media-amazon.com/images/I/41fNI3t5hYS.jpg
- https://www.amazon.com/Sixriver-Crimper-Straightener-Crimping-Volumizing/dp/B0C85XZFM8?tag=all0ad0-21https://m.media-amazon.com/images/I/51OrfENeNCL.jpg
- https://www.amazon.com/Skyfoot-Adjustable-Increase-Insoles-Cushioning/dp/B0BN5V3PPF?tag=all0ad0-21https://m.media-amazon.com/images/I/41uwN2FiiiL.jpg
- https://www.amazon.com/skysen-Magnetic-Decorative-Handles-Hardware/dp/B07L72D7FX?tag=all0ad0-21https://m.media-amazon.com/images/I/51AIynaJumL.jpg
- https://www.amazon.com/STAR-WARS-SW-Halloween-Wookiee/dp/B0BHZVTNQV?tag=all0ad0-21https://m.media-amazon.com/images/I/411fjZsBYrL.jpg
- https://www.amazon.com/Stens-375-402-Black-Decker-82-020/dp/B01H5K2QSQ?tag=all0ad0-21https://m.media-amazon.com/images/I/21Tkj5Btb0L.jpg
- https://www.amazon.com/Stickers-Bottles-Waterproof-Animals-Skateboard/dp/B09S3JSNV3?tag=all0ad0-21https://m.media-amazon.com/images/I/61E2JiiBkML.jpg
- https://www.amazon.com/Still-Just-Geek-Annotated-Memoir/dp/B09HZB3WGP?tag=all0ad0-21https://m.media-amazon.com/images/I/51Ee05wyCwL.jpg
- https://www.amazon.com/Straightener-MiroPure-Straightening-Anti-Scald-Temperature/dp/B06XGXP9RP?tag=all0ad0-21https://m.media-amazon.com/images/I/41okvbcUEnL.jpg
- https://www.amazon.com/Summit-Treestands-Replacement-Cables-Climbing/dp/B001BAGLXI?tag=all0ad0-21https://m.media-amazon.com/images/I/41vANZDPuCL.jpg
- https://www.amazon.com/Support-Car-Car-Support-Memory-Car-Driving/dp/B07MV5X84K?tag=all0ad0-21https://m.media-amazon.com/images/I/51iEP2LoKmL.jpg
- https://www.amazon.com/Surface-Charger-Microsoft-Compatible-Laptop/dp/B0BW41H1W2?tag=all0ad0-21https://m.media-amazon.com/images/I/31Xt8mDjKyL.jpg
- https://www.amazon.com/Survival-Essentials-Tactical-Emergency-Activities/dp/B0BFFC8ZTV?tag=all0ad0-21https://m.media-amazon.com/images/I/512QQyOIcjL.jpg
- https://www.amazon.com/SwaggWood-Certified-Lightning-Charging-Compatible/dp/B0CFQF6LS6?tag=all0ad0-21https://m.media-amazon.com/images/I/41vq56QWFNL.jpg
- https://www.amazon.com/Tablecloth-Disposable-Surfboard-Rectangle-Birthday/dp/B09X2GK6Z7?tag=all0ad0-21https://m.media-amazon.com/images/I/51M30CIsW2L.jpg
- https://www.amazon.com/Tanming-Womens-Seamless-Workout-Running/dp/B0BHY73PWB?tag=all0ad0-21https://m.media-amazon.com/images/I/310AJZGSfCL.jpg
- https://www.amazon.com/Tear-off-Productivity-Anna-Marie-Collections/dp/B09GDDCMJP?tag=all0ad0-21https://m.media-amazon.com/images/I/41yZVQwPEZL.jpg
- https://www.amazon.com/Textures-Graphite-Charcoal-Steven-Pearce-ebook/dp/B01N7Y0XP5?tag=all0ad0-21https://m.media-amazon.com/images/I/61XIPXXBL5L.jpg
- https://www.amazon.com/The-Beginning-of-Everything-audiobook/dp/B081NXJVT5?tag=all0ad0-21https://m.media-amazon.com/images/I/51aG06izsLL.jpg
- https://www.amazon.com/The-Enlightenment/dp/B07VHFHN3Y?tag=all0ad0-21https://m.media-amazon.com/images/I/51ArbS5NSDL.jpg
- https://www.amazon.com/The-Good-Lie/dp/B08QVNGF3M?tag=all0ad0-21https://m.media-amazon.com/images/I/51UPMGqzseS.jpg
- https://www.amazon.com/Thermal-Moisture-Wicking-Breathable-Charcoal/dp/B0929CZSL2?tag=all0ad0-21https://m.media-amazon.com/images/I/61GFFLF2InL.jpg
- https://www.amazon.com/Tiny-Worlds-flashcards-Preschoolers-FlashCards/dp/9811186480?tag=all0ad0-21https://m.media-amazon.com/images/I/51Du0jKtPzL.jpg
- https://www.amazon.com/TOZO-G1-Headphones-Sensitivity-Low-Latency/dp/B0B31GZW61?tag=all0ad0-21https://m.media-amazon.com/images/I/41E2gk95+aL.jpg
- https://www.amazon.com/Traffic-Secrets-Underground-Playbook-Customers/dp/B08B9XH6KH?tag=all0ad0-21https://m.media-amazon.com/images/I/51hWa7NS0NL.jpg
- https://www.amazon.com/Twinkle-Star-Decorative-Waterproof-Decorations/dp/B098JY29L7?tag=all0ad0-21https://m.media-amazon.com/images/I/616wtcSojML.jpg
- https://www.amazon.com/TWOPAN-Docking-Station-Charging-Reader/dp/B08DP397VJ?tag=all0ad0-21https://m.media-amazon.com/images/I/51uMUogb87L.jpg
- https://www.amazon.com/ULA-YUAN-Earrings-Sterling-Lightweight-Zirconia/dp/B0C4TD5XT1?tag=all0ad0-21https://m.media-amazon.com/images/I/41xB7mwzhLL.jpg
- https://www.amazon.com/Ultrean-Scale%EF%BC%8C33lb-Graduation-Rechargeable-Function/dp/B0C4T7DYPF?tag=all0ad0-21https://m.media-amazon.com/images/I/51AeRXTVp5L.jpg
- https://www.amazon.com/undercoat-grooming-couch-remover-cleaning/dp/B0BQXW1KKT?tag=all0ad0-21https://m.media-amazon.com/images/I/412YRiMjcUL.jpg
- https://www.amazon.com/Unfinished-Large-Unpainted-Birthday-Decoration/dp/B0C8YQCQBY?tag=all0ad0-21https://m.media-amazon.com/images/I/31bPd6gVmSL.jpg
- https://www.amazon.com/UniLiGis-Washable-Backpack-Adjustable-Drawstring/dp/B08CDZDKP2?tag=all0ad0-21https://m.media-amazon.com/images/I/413CAK6mBXL.jpg
- https://www.amazon.com/Uniquewise-QI003353R-L-Handcrafted-Burgundy-Natural/dp/B07F866473?tag=all0ad0-21https://m.media-amazon.com/images/I/313YcWeXFoL.jpg
- https://www.amazon.com/VacLife-Cordless-Charger-350CFM-Electric-High-Speed/dp/B0C6MZZLTT?tag=all0ad0-21https://m.media-amazon.com/images/I/41bEaK78nKL.jpg
- https://www.amazon.com/VAV-Infrared-Strong-Diffuser-Concentrator/dp/B07H8SR9K7?tag=all0ad0-21https://m.media-amazon.com/images/I/41uNl6-KSPL.jpg
- https://www.amazon.com/Vilucks-Reusable-Universal-Microfiber-Cloths/dp/B09TPPK2T6?tag=all0ad0-21https://m.media-amazon.com/images/I/21tCfu9A9wL.jpg
- https://www.amazon.com/Vooii-iPhone-Silicone-Protective-Microfiber/dp/B07Z7LY135?tag=all0ad0-21https://m.media-amazon.com/images/I/41LTfdLnNVL.jpg
- https://www.amazon.com/Walking-Sam-Father-Hundred-Across/dp/B0BJ14HHVD?tag=all0ad0-21https://m.media-amazon.com/images/I/51xw7IcZbAL.jpg
- https://www.amazon.com/Watchers-gripping-debut-horror-novel-ebook/dp/B08TP9ZQY5?tag=all0ad0-21https://m.media-amazon.com/images/I/41g5T7Vj8vL.jpg
- https://www.amazon.com/Waterproof-Exquisitely-Lengthening-Thickening-Smudge-Proof/dp/B09FJK67YH?tag=all0ad0-21https://m.media-amazon.com/images/I/51X6cb5qVvL.jpg
- https://www.amazon.com/Waterproof-Toddler-Automatic-Sprinkler-Induction/dp/B0BFB53X61?tag=all0ad0-21https://m.media-amazon.com/images/I/51hZjr8pPCL.jpg
- https://www.amazon.com/Webroot-Internet-Antivirus-Protection-Subscription/dp/B07DDL3N69?tag=all0ad0-21https://m.media-amazon.com/images/I/41engcvUs-L.jpg
- https://www.amazon.com/Welcome-Retriever-Sunflowers-Farmhouse-Decorations/dp/B0BX4CGRZ6?tag=all0ad0-21https://m.media-amazon.com/images/I/51mDBvSQDgL.jpg
- https://www.amazon.com/Westinghouse-6361700-One-Light-Barnwood-Accents/dp/B07FV24JKY?tag=all0ad0-21https://m.media-amazon.com/images/I/31CAM-d4pHL.jpg
- https://www.amazon.com/whall-Cordless-Upgraded-Brushless-Lightweight/dp/B0CCS6K9ZQ?tag=all0ad0-21https://m.media-amazon.com/images/I/41yccuwbFUL.jpg
- https://www.amazon.com/Wildfire-Street-Rats-Aramoor-Book/dp/B09TQ2N654?tag=all0ad0-21https://m.media-amazon.com/images/I/616qu3UwE1L.jpg
- https://www.amazon.com/Women-Socks-Winter-Womens-Pairs/dp/B0B51QC6YX?tag=all0ad0-21https://m.media-amazon.com/images/I/51ewD5NWbWL.jpg
- https://www.amazon.com/Womens-Shoulder-Striped-Jumpsuits-Rompers/dp/B09SJ1G85L?tag=all0ad0-21https://m.media-amazon.com/images/I/41YYqXXx5dL.jpg
- https://www.amazon.com/Wozukia-Watercolor-MatInteresting-Amphibians-Decoration/dp/B0BYF9D2FX?tag=all0ad0-21https://m.media-amazon.com/images/I/518pUiLOefL.jpg
- https://www.amazon.com/X-cosrack-Organizer-Adjustable-Multifunctional-Cabinets/dp/B08BZMX161?tag=all0ad0-21https://m.media-amazon.com/images/I/51pk2BkIxjL.jpg
- https://www.amazon.com/XIOYIG-Tabletop-Portable-Concrete-Fireplace/dp/B0BJPD1Y4S?tag=all0ad0-21https://m.media-amazon.com/images/I/31ESaKZWI5L.jpg
- https://www.amazon.com/Y-W-Y-Bracelet-Mermaid-Jewelry-Supplies/dp/B095Y3SGBT?tag=all0ad0-21https://m.media-amazon.com/images/I/81mmuW14WML.jpg
- https://www.amazon.com/YaberAuto-Battery-Portable-Extended-Charging/dp/B0C4Y9NTQT?tag=all0ad0-21https://m.media-amazon.com/images/I/51GZ73w-xSL.jpg
- https://www.amazon.com/Yicostar-Walking-Collapsible-Portable-Dispenser/dp/B08XYWNVPP?tag=all0ad0-21https://m.media-amazon.com/images/I/31XbaAaEM-L.jpg
- https://www.amazon.com/YONHISDAT-Rechargerable-Circulation-360%C2%B0Rotation-Vehicles/dp/B0C1G12PFH?tag=all0ad0-21https://m.media-amazon.com/images/I/412XGJmpeoL.jpg
- https://www.amazon.com/YORKING-Headlights-Rectangular-Freightinger-Oldsmobile/dp/B07CF7JVTN?tag=all0ad0-21https://m.media-amazon.com/images/I/61XCciZBQTL.jpg
- https://www.amazon.com/YOU-WIZV-Keychain-Cartoon-Accessory/dp/B0BPJ3RJL6?tag=all0ad0-21https://m.media-amazon.com/images/I/41kdT+esfOL.jpg
- https://www.amazon.com/YOYI-Sandproof-Lightweight-Waterproof-Festivals/dp/B0C2SRR115?tag=all0ad0-21https://m.media-amazon.com/images/I/61NsvKATXeL.jpg
Categories
- https://www.amazon.com/2020-2021-Planner-Academic-Do-Twin-Wire/dp/B083V11TM5?tag=all0ad0-21https://m.media-amazon.com/images/I/41btLRSWksL.jpg (1)
- https://www.amazon.com/Acid-Dreams-Complete-History-Sixties-ebook/dp/B005012G6U?tag=all0ad0-21https://m.media-amazon.com/images/I/51SwQkWyzAL.jpg (1)
- https://www.amazon.com/Adaptive-Charging-Charger-Compatible-EP-TA20JBE/dp/B07NPD5T5H?tag=all0ad0-21https://m.media-amazon.com/images/I/419ZKbzdOwL.jpg (1)
- https://www.amazon.com/Adjustable-Foldable-Portable-Compatible-Smartphones/dp/B0963PBY4C?tag=all0ad0-21https://m.media-amazon.com/images/I/51p4wF13kCL.jpg (1)
- https://www.amazon.com/African-Twisted-Headwraps-Headband-Headscarf/dp/B09FDMKTZP?tag=all0ad0-21https://m.media-amazon.com/images/I/41WGbzL+RkL.jpg (3)
- https://www.amazon.com/AINOPE-Charging-Braided-compatible-MacBook/dp/B094YDZQ1C?tag=all0ad0-21https://m.media-amazon.com/images/I/51ppc0xIVtL.jpg (1)
- https://www.amazon.com/Ambergris-Saints-Madmen-Shriek-Finch/dp/B08GGCSN3S?tag=all0ad0-21https://m.media-amazon.com/images/I/51zgVCTiUiL.jpg (1)
- https://www.amazon.com/Amplim-Hospital-Thermometer-Professional-Thermometer/dp/B0865R5H82?tag=all0ad0-21https://m.media-amazon.com/images/I/31K01H4s6UL.jpg (1)
- https://www.amazon.com/Animal-Gaming-Electronic-Lights-Birthday/dp/B0B2QTLWMS?tag=all0ad0-21https://m.media-amazon.com/images/I/41GY22qHwkL.jpg (2)
- https://www.amazon.com/Animals-Flashcards-Children-Alphabet-cards/dp/9811168881?tag=all0ad0-21https://m.media-amazon.com/images/I/51U2gcSb62L.jpg (1)
- https://www.amazon.com/ANNKIE-Dance-Electronic-Lights-Birthday/dp/B0B74DVQQV?tag=all0ad0-21https://m.media-amazon.com/images/I/51K45aP99DL.jpg (1)
- https://www.amazon.com/Anti-Wrinkle-Silicone-Reusable-D%C3%A9collet%C3%A9-Eliminate/dp/B07FQ3QV1C?tag=all0ad0-21https://m.media-amazon.com/images/I/41RhHEsEi3L.jpg (1)
- https://www.amazon.com/anyloop-Military-Smartwatch-Bluetooth-Waterproof/dp/B0C4P7R6CK?tag=all0ad0-21https://m.media-amazon.com/images/I/41lUAHTmi5L.jpg (2)
- https://www.amazon.com/Aromatherapy-Shower-Steamers-Relaxation-Everything/dp/B08QDKWBWS?tag=all0ad0-21https://m.media-amazon.com/images/I/613KwmLJJ1L.jpg (1)
- https://www.amazon.com/Audible-A-Rose-in-Winter/dp/B09JHTGT14?tag=all0ad0-21https://m.media-amazon.com/images/I/51z1bVj4CxL.jpg (1)
- https://www.amazon.com/Audible-Fall-School-Good-Evil/dp/B0B8SZY3P5?tag=all0ad0-21https://m.media-amazon.com/images/I/51MWO0bOLIL.jpg (1)
- https://www.amazon.com/Audible-Termination-Shock-A-Novel/dp/B09556Y79B?tag=all0ad0-21https://m.media-amazon.com/images/I/51jEsfJXG3S.jpg (1)
- https://www.amazon.com/Automatic-Toddlers-Operated-Batteries-Birthday/dp/B0BZH34G2G?tag=all0ad0-21https://m.media-amazon.com/images/I/51PQaTAouaL.jpg (2)
- https://www.amazon.com/AWGOU-Baby-Wipes-Dispenser-Large-Capacity/dp/B0BS3K9BFV?tag=all0ad0-21https://m.media-amazon.com/images/I/41emlsr6WnL.jpg (2)
- https://www.amazon.com/AYAO-Blades-8-Inch-12TPI-2-Pack/dp/B0C9C1VB3D?tag=all0ad0-21https://m.media-amazon.com/images/I/41jMumgfJ4L.jpg (1)
- https://www.amazon.com/Backless-Sleeve-Ribbed-Fitted-Shirts/dp/B0B68KPGP8?tag=all0ad0-21https://m.media-amazon.com/images/I/41vB0uLnuzL.jpg (1)
- https://www.amazon.com/BCHWAY-Stuffed-Storage-Beanbag-Organizer/dp/B09WR2KPPG?tag=all0ad0-21https://m.media-amazon.com/images/I/41GBr+1tEBL.jpg (1)
- https://www.amazon.com/beeprt-Bluetooth-Shipping-Label-Printer/dp/B0BK93ZSNC?tag=all0ad0-21https://m.media-amazon.com/images/I/41Ufm05KrJL.jpg (1)
- https://www.amazon.com/Benewid-Creami-Pints-Lids-Containers/dp/B0C85Q44N6?tag=all0ad0-21https://m.media-amazon.com/images/I/41bFv6o0xjL.jpg (1)
- https://www.amazon.com/BIG-TEETH-Magnetic-Microfiber-5-Piece/dp/B0BRXBM2T9?tag=all0ad0-21https://m.media-amazon.com/images/I/51BCt4B8jDL.jpg (1)
- https://www.amazon.com/Blackbeard-Americas-Most-Notorious-Pirate/dp/B086N4X4SG?tag=all0ad0-21https://m.media-amazon.com/images/I/51fqeuICW+L.jpg (1)
- https://www.amazon.com/Blaster-Automatic-Toddlers-Christmas-Birthday/dp/B0CCV9RDM5?tag=all0ad0-21https://m.media-amazon.com/images/I/51j8FkZtBiL.jpg (1)
- https://www.amazon.com/Bloodline-Jess-Lourey/dp/1542016312?tag=all0ad0-21https://m.media-amazon.com/images/I/51KLqBsOIbL.jpg (1)
- https://www.amazon.com/Bracelet-Stainless-Zirconium-Ceramic-Statement/dp/B0B2CQR5YW?tag=all0ad0-21https://m.media-amazon.com/images/I/41iUmnfsAmL.jpg (1)
- https://www.amazon.com/Bride-Shadow-King-Book/dp/B0B75RL7DX?tag=all0ad0-21https://m.media-amazon.com/images/I/51LyIt-n5+L.jpg (1)
- https://www.amazon.com/Bright-Empires-House-Spirit-Shadow/dp/B08T4VG1S2?tag=all0ad0-21https://m.media-amazon.com/images/I/61-JxjVNClL.jpg (1)
- https://www.amazon.com/BRIGHTWORLD-Stuffers-Upgrade-5-9inch-Birthday/dp/B0B6RBCYZ7?tag=all0ad0-21https://m.media-amazon.com/images/I/61pQaIf3NVL.jpg (1)
- https://www.amazon.com/Bunfly-Clipper-Grooming-Suction-Capacity/dp/B0C6PMSY3Z?tag=all0ad0-21https://m.media-amazon.com/images/I/51ig7m1g9OL.jpg (1)
- https://www.amazon.com/C412H-Spring-Wound-Commercial-12-Hour-Automatic/dp/B00CTW2LYA?tag=all0ad0-21https://m.media-amazon.com/images/I/41QNVA+3MRL.jpg (1)
- https://www.amazon.com/Cardone-Select-84-832-Ignition-Distributor/dp/B000CFFAYY?tag=all0ad0-21https://m.media-amazon.com/images/I/414iGfzryML.jpg (1)
- https://www.amazon.com/ceiba-tree-Graduation-Envelopes-Classroom/dp/B0BQQKSLFK?tag=all0ad0-21https://m.media-amazon.com/images/I/51ZOS4YOvzL.jpg (2)
- https://www.amazon.com/CellElection-Elastic-Ponytail-Holders-Straight/dp/B09TFDLR85?tag=all0ad0-21https://m.media-amazon.com/images/I/514QbooGKKL.jpg (1)
- https://www.amazon.com/Certified-Charger-Charging-Braveridge-Lightning/dp/B0C1VKRXN1?tag=all0ad0-21https://m.media-amazon.com/images/I/41XG+lopk8L.jpg (1)
- https://www.amazon.com/Certified%E3%80%91-Charger-Fasting-Charging-Compatible/dp/B0C489SXGB?tag=all0ad0-21https://m.media-amazon.com/images/I/41dNzZS3BML.jpg (1)
- https://www.amazon.com/Charger-Certified-Lightning-Charging-Compatible/dp/B0C4L9S7QH?tag=all0ad0-21https://m.media-amazon.com/images/I/514iP4Fy28L.jpg (1)
- https://www.amazon.com/Chicken-Shredder-Ergonomic-Anti-Slip-Dishwasher/dp/B0C5R1KZP6?tag=all0ad0-21https://m.media-amazon.com/images/I/61cx6f737WL.jpg (1)
- https://www.amazon.com/Christmas-Decorations-PHITRIC-Sparkling-Fireplace/dp/B0B7WNC93J?tag=all0ad0-21https://m.media-amazon.com/images/I/51Gv07W+JCL.jpg (1)
- https://www.amazon.com/Christmas-Snowflake-Stamping-Manicure-Designer/dp/B09L4SV5YY?tag=all0ad0-21https://m.media-amazon.com/images/I/51TQJxPWLrL.jpg (1)
- https://www.amazon.com/Cleaning-Bathroom-Crevice-Bristle-Multifunctional/dp/B0CDBK4C9T?tag=all0ad0-21https://m.media-amazon.com/images/I/415dsUeaDmL.jpg (1)
- https://www.amazon.com/Clinic-Crohns-Disease-Ulcerative-Colitis-ebook/dp/B09ZBLJLFL?tag=all0ad0-21https://m.media-amazon.com/images/I/41f5FHJle+L.jpg (1)
- https://www.amazon.com/Coasters-Absorbent-Ceramic-Coaster-Housewarming/dp/B09ZKJRSLH?tag=all0ad0-21https://m.media-amazon.com/images/I/51POqbEgyOL.jpg (2)
- https://www.amazon.com/CoBak-Rotating-Case-iPad-Generation/dp/B0BBR8MFHM?tag=all0ad0-21https://m.media-amazon.com/images/I/516NR1N0QKL.jpg (1)
- https://www.amazon.com/COLORFULLEAF-Bamboo-Underwear-Breathable-Trunks/dp/B0B9BX5S9L?tag=all0ad0-21https://m.media-amazon.com/images/I/31MYPhHHapL.jpg (1)
- https://www.amazon.com/Comforter-Paisley-Microfiber-Bohemian-Pillowcases/dp/B0BZP1SC6F?tag=all0ad0-21https://m.media-amazon.com/images/I/51KkoN3AgNL.jpg (1)
- https://www.amazon.com/Compressed-Cordless-Electric-Brushless-Portable/dp/B0BBR1XHLS?tag=all0ad0-21https://m.media-amazon.com/images/I/41dJ2sJpGjL.jpg (1)
- https://www.amazon.com/Cordking-14-Protectors-Shockproof-Microfiber/dp/B0B6GKRCGM?tag=all0ad0-21https://m.media-amazon.com/images/I/41tXMeWi5FL.jpg (1)
- https://www.amazon.com/Cordless-High-Speed-Brushless-Lightweight-Cleaners/dp/B0CGL8NBM8?tag=all0ad0-21https://m.media-amazon.com/images/I/41NfsXSEnLL.jpg (1)
- https://www.amazon.com/Cordless-Straightening-Travel-Wireless-Straightener/dp/B0CJ2HQL3H?tag=all0ad0-21https://m.media-amazon.com/images/I/31wTmdUZyuL.jpg (1)
- https://www.amazon.com/Corrector-Clavicle-Adjustable-Straightener-Providing/dp/B07L41CV8B?tag=all0ad0-21https://m.media-amazon.com/images/I/41B0xbK2kRL.jpg (1)
- https://www.amazon.com/Court-Wizard-Terry-Mancour-audiobook/dp/B07PC2RQSC?tag=all0ad0-21https://m.media-amazon.com/images/I/512jFQbt6JL.jpg (1)
- https://www.amazon.com/Cozivwaiy-Platform-Sandals-Studded-Evening/dp/B0BM43W7VF?tag=all0ad0-21https://m.media-amazon.com/images/I/41+RFM1gP7L.jpg (3)
- https://www.amazon.com/Crenova-Magnetic-Construction-Preschool-Educational/dp/B0CC1RZ2BJ?tag=all0ad0-21https://m.media-amazon.com/images/I/51lJxAlaL3L.jpg (1)
- https://www.amazon.com/Dan-Darci-Marbling-Paint-Kids/dp/B08CLVVJ8C?tag=all0ad0-21https://m.media-amazon.com/images/I/61nDIOC0B0L.jpg (1)
- https://www.amazon.com/Dash-Cam-Front-BOOGIIO-Dashboard/dp/B08LZJ8GMH?tag=all0ad0-21https://m.media-amazon.com/images/I/41B3QK42N1L.jpg (1)
- https://www.amazon.com/Democracy-America-What-Wrong-About-ebook/dp/B0867TRV52?tag=all0ad0-21https://m.media-amazon.com/images/I/4129LSadlmL.jpg (1)
- https://www.amazon.com/Detailing-Attachment-Scrubber-Cleaning-Upholstery/dp/B07WGKQVN7?tag=all0ad0-21https://m.media-amazon.com/images/I/41K75BhGaML.jpg (2)
- https://www.amazon.com/Diameter-Hydrophilic-Filtration-Non-sterile-COBETTER/dp/B0B7BB3L1R?tag=all0ad0-21https://m.media-amazon.com/images/I/31KD4E7TW5L.jpg (1)
- https://www.amazon.com/Diamond-Organizer-Jewelry-Storage-Diamonds/dp/B08JLVSZ15?tag=all0ad0-21https://m.media-amazon.com/images/I/514Z+bbZfQL.jpg (1)
- https://www.amazon.com/Diamond-Painting-Diamonds-12x16inch-30%C3%9740cm/dp/B09X1CQJHX?tag=all0ad0-21https://m.media-amazon.com/images/I/51xEpqCkI-L.jpg (1)
- https://www.amazon.com/didforu-Monocular-Telescope-Monoscope-Binocular/dp/B0C3757D5G?tag=all0ad0-21https://m.media-amazon.com/images/I/512qer0p1oL.jpg (1)
- https://www.amazon.com/Dinkhiiro-Outdoor-Pickleball-Balls-Pickle-Ball-Accessories-Pickleball/dp/B0BNQ8HM76?tag=all0ad0-21https://m.media-amazon.com/images/I/41ni+GPR71L.jpg (3)
- https://www.amazon.com/Distant-Horizon-Backyard-Starship-Book/dp/B0BDP9RPQL?tag=all0ad0-21https://m.media-amazon.com/images/I/512FYS+c9wL.jpg (1)
- https://www.amazon.com/Dorman-1650134-Chevrolet-Driver-Assembly/dp/B00JW1XGDG?tag=all0ad0-21https://m.media-amazon.com/images/I/51p-ja2Vc9L.jpg (2)
- https://www.amazon.com/DosTutu-Mermaid-Costume-Pageant-Birthday/dp/B09NJK6K9M?tag=all0ad0-21https://m.media-amazon.com/images/I/51pVYQBZKJL.jpg (1)
- https://www.amazon.com/dp/B09GFWPXWH?tag=all0ad0-21https://m.media-amazon.com/images/I/51xO7ZL-sVL.jpg (1)
- https://www.amazon.com/DREAMS-VISIONS-Jesus-Awakening-Muslim-ebook/dp/B0078FAA3M?tag=all0ad0-21https://m.media-amazon.com/images/I/51BKVftuXDL.jpg (1)
- https://www.amazon.com/DSJUGGLING-Transparent-Two-Tone-Juggling-Beginners/dp/B09WHRZCFF?tag=all0ad0-21https://m.media-amazon.com/images/I/419NOeSGijL.jpg (1)
- https://www.amazon.com/Empire-of-Storms-Sarah-J-Maas-audiobook/dp/B01KIQV5EU?tag=all0ad0-21https://m.media-amazon.com/images/I/51EMceUgxFL.jpg (1)
- https://www.amazon.com/Eniucow-Montessori-Permanent-Traction-Toddlers/dp/B0B7CZ9KGN?tag=all0ad0-21https://m.media-amazon.com/images/I/31bJyZYqhJL.jpg (1)
- https://www.amazon.com/Eslazoer-insulated-neoprene-reusable-activity/dp/B0BKSMXVN8?tag=all0ad0-21https://m.media-amazon.com/images/I/41kTXH2JxBL.jpg (1)
- https://www.amazon.com/Everyday-Solutions-Mug-Tree-Polished/dp/B0B4T6NCML?tag=all0ad0-21https://m.media-amazon.com/images/I/31-7RTd1fUL.jpg (1)
- https://www.amazon.com/Extender-Universal-Rotatable-Extension-Attachment/dp/B0C4YLVH3D?tag=all0ad0-21https://m.media-amazon.com/images/I/41+YysChcFL.jpg (2)
- https://www.amazon.com/Eyelash-Extension-Cleanser-BREYLEE-Shampoo/dp/B08RJFTFN4?tag=all0ad0-21https://m.media-amazon.com/images/I/51UncwwSzwL.jpg (1)
- https://www.amazon.com/Fatal-Discord-Michael-Massing-audiobook/dp/B078YDCMBD?tag=all0ad0-21https://m.media-amazon.com/images/I/51AJdROll+L.jpg (1)
- https://www.amazon.com/Faucet-Sprayer-Attachment-Replacement-included/dp/B0BCFMT7WY?tag=all0ad0-21https://m.media-amazon.com/images/I/31wZDbk-bYL.jpg (1)
- https://www.amazon.com/Feeling-Good-David-D-Burns-audiobook/dp/B01N9TCVLD?tag=all0ad0-21https://m.media-amazon.com/images/I/51ixV6lf9AL.jpg (1)
- https://www.amazon.com/FeelinGirl-Waitsted-Shapewear-Control-Lifting/dp/B0CBK29G76?tag=all0ad0-21https://m.media-amazon.com/images/I/31Cl6qaK0HL.jpg (1)
- https://www.amazon.com/Fenceguru-Decorative-Rustproof-Barrier-Landscape/dp/B0BZ91ZPHF?tag=all0ad0-21https://m.media-amazon.com/images/I/519kGS3sjxL.jpg (1)
- https://www.amazon.com/Fernco-PQC-105-Flexible-Reusable-Plastic/dp/B00CFVNCCK?tag=all0ad0-21https://m.media-amazon.com/images/I/21xcHMaS37L.jpg (1)
- https://www.amazon.com/Floating-Shelves-Bathroom-Bedroom-Kitchen/dp/B0CF8J497J?tag=all0ad0-21https://m.media-amazon.com/images/I/51cT9HpSh4L.jpg (2)
- https://www.amazon.com/Forehead-Thermometer-Infrared-Eligible-Indicator/dp/B0B4ZD6K43?tag=all0ad0-21https://m.media-amazon.com/images/I/31J97vQVUHL.jpg (2)
- https://www.amazon.com/FRGROW-Lights-Spectrum-Function-Gooseneck/dp/B0CC4P13L7?tag=all0ad0-21https://m.media-amazon.com/images/I/51UXtap-56L.jpg (2)
- https://www.amazon.com/Funrous-Mattress-Lifter-Helper-Stainless/dp/B09WMZPM1N?tag=all0ad0-21https://m.media-amazon.com/images/I/31Vg6rJibzL.jpg (1)
- https://www.amazon.com/GAOY-Glassy-Foundation-Combination-Polish/dp/B0BD4MMFVM?tag=all0ad0-21https://m.media-amazon.com/images/I/414wIShbm+L.jpg (1)
- https://www.amazon.com/Gay-Pride-Rainbow-Heart-Silicone/dp/B01J8E5NUA?tag=all0ad0-21https://m.media-amazon.com/images/I/31TtNjUl3uL.jpg (2)
- https://www.amazon.com/Gerod-Compatible-Replacement-Cushions-Headphones/dp/B09BPV34ZB?tag=all0ad0-21https://m.media-amazon.com/images/I/41cXXPmWNoL.jpg (2)
- https://www.amazon.com/GetKen-Dispenser-Rechargeable-Portable-Automatic/dp/B0C4T26LK4?tag=all0ad0-21https://m.media-amazon.com/images/I/41v5jE7AsIL.jpg (1)
- https://www.amazon.com/Gifts-Girls-birthday-Toys-Duplication/dp/B0B6FY328P?tag=all0ad0-21https://m.media-amazon.com/images/I/51mMmkuwdfL.jpg (1)
- https://www.amazon.com/Girls-Charm-Bracelet-Making-Kit/dp/B0CFCC8HBZ?tag=all0ad0-21https://m.media-amazon.com/images/I/81-SB1q4h1L.jpg (1)
- https://www.amazon.com/Girls-Charm-Bracelet-Making-Kit/dp/B0CFF3SLJT?tag=all0ad0-21https://m.media-amazon.com/images/I/81kJ83iM+IL.jpg (1)
- https://www.amazon.com/GloFX-Blue-Rave-Bedroom-Decor/dp/B0B7ZXG6PS?tag=all0ad0-21https://m.media-amazon.com/images/I/41iPdpfs1DL.jpg (1)
- https://www.amazon.com/GMSOL-Diamond-Necklaces-Necklace-Layered/dp/B0BXKY3XW9?tag=all0ad0-21https://m.media-amazon.com/images/I/21iQgpW3i4L.jpg (1)
- https://www.amazon.com/Greenland-Home-GL-THROWSH-Shangri-La-Throw/dp/B017U6U8JO?tag=all0ad0-21https://m.media-amazon.com/images/I/61VISLraXWL.jpg (1)
- https://www.amazon.com/Gyierwe-High-Pressure-Stainless-Adjustable-Filtration/dp/B0C5RHCSN8?tag=all0ad0-21https://m.media-amazon.com/images/I/51RZ3tTLzyL.jpg (1)
- https://www.amazon.com/Halloween-Decorations-Indoor-DECSPAS-Haunted/dp/B0C6JPZ6K5?tag=all0ad0-21https://m.media-amazon.com/images/I/51zSmWVx7HL.jpg (1)
- https://www.amazon.com/HawSkgFub-Curtains-Farmhouse-Seasonal-Bathroom/dp/B0BVLTJR4P?tag=all0ad0-21https://m.media-amazon.com/images/I/412k-TN9yzL.jpg (2)
- https://www.amazon.com/Helping-Soldering-Hand-Base-Microscope/dp/B0BBR46ZQ9?tag=all0ad0-21https://m.media-amazon.com/images/I/41IZoepkAkL.jpg (2)
- https://www.amazon.com/Her-Soul-Take-Souls-Trilogy/dp/B0BDT2M2QZ?tag=all0ad0-21https://m.media-amazon.com/images/I/51Z1AUkTytL.jpg (1)
- https://www.amazon.com/HISANDUK-Pendant-Fixtures-Kitchen-Adjustable/dp/B0B76G6VCT?tag=all0ad0-21https://m.media-amazon.com/images/I/41SzQX+tAeL.jpg (1)
- https://www.amazon.com/Homeleo-Operated-Christmas-Strawberry-Decorations/dp/B07WTVGTWX?tag=all0ad0-21https://m.media-amazon.com/images/I/51+CNn9QowL.jpg (1)
- https://www.amazon.com/House-of-Impossible-Beauties-audiobook/dp/B077VQ68HH?tag=all0ad0-21https://m.media-amazon.com/images/I/51VFkDIrDsL.jpg (1)
- https://www.amazon.com/HOUSE-Organizer-Upgraded-Undersink-Organizers/dp/B0BY8XZK71?tag=all0ad0-21https://m.media-amazon.com/images/I/510FKKVDhpL.jpg (1)
- https://www.amazon.com/House-Witch-Humorous-Romantic-Fantasy/dp/B0BLJ7CQKK?tag=all0ad0-21https://m.media-amazon.com/images/I/61+JJSw9jZL.jpg (1)
- https://www.amazon.com/HR-Quadcopter-Beginners-Altitude-Batteries/dp/B08L8YFT4S?tag=all0ad0-21https://m.media-amazon.com/images/I/41pf-DNDj5L.jpg (1)
- https://www.amazon.com/Humble-Chic-Wall-Art-Prints/dp/B07QL3GTX4?tag=all0ad0-21https://m.media-amazon.com/images/I/31QO1OLNDGL.jpg (1)
- https://www.amazon.com/Huyerdo-Corduroy-Cosmetic-Aesthetic-Organizer/dp/B0C1YXPX5M?tag=all0ad0-21https://m.media-amazon.com/images/I/51Es7IjWzjL.jpg (1)
- https://www.amazon.com/I-Invited-Her-In-Adele-Parks-audiobook/dp/B07JZGFFHY?tag=all0ad0-21https://m.media-amazon.com/images/I/51ak3gyHziL.jpg (1)
- https://www.amazon.com/In1docom-Peanut-Massage-Massager-Lacrosse/dp/B0CB4S2JRX?tag=all0ad0-21https://m.media-amazon.com/images/I/41sBnhqhZzL.jpg (1)
- https://www.amazon.com/INeedIt-D101-Portable-Wireless-Organization/dp/B0BCKV8B81?tag=all0ad0-21https://m.media-amazon.com/images/I/21OGF1G7x9L.jpg (1)
- https://www.amazon.com/Inflatable-Ground-Dustproof-Rainproof-Waterproof/dp/B0CB8B4PKX?tag=all0ad0-21https://m.media-amazon.com/images/I/51o0yuVrjPL.jpg (1)
- https://www.amazon.com/Insane-Labz-Bitartrate-AMPiberry-Endurance/dp/B07V6JCWJG?tag=all0ad0-21https://m.media-amazon.com/images/I/51GZtu2lUZL.jpg (1)
- https://www.amazon.com/Island-Queen-A-Novel/dp/B08MLPY619?tag=all0ad0-21https://m.media-amazon.com/images/I/51snO62ltvL.jpg (1)
- https://www.amazon.com/J-hong-Toddlers-Learning-Montessori-Christmas/dp/B0C4LK67Q5?tag=all0ad0-21https://m.media-amazon.com/images/I/51q4mMYfoLL.jpg (1)
- https://www.amazon.com/jalz-Wooden-Spoons-Cooking-3-Piece/dp/B07DZKTC9B?tag=all0ad0-21https://m.media-amazon.com/images/I/416iXJ1B8PL.jpg (1)
- https://www.amazon.com/JENN-ARDOR-Fashion-Sneakers-Comfortable/dp/B08N16X7HR?tag=all0ad0-21https://m.media-amazon.com/images/I/41y+m0CTBeS.jpg (1)
- https://www.amazon.com/John-Sterling-Sports-7-Ball-Capacity/dp/B01DWSH1I0?tag=all0ad0-21https://m.media-amazon.com/images/I/31-O3z3v+XL.jpg (2)
- https://www.amazon.com/Jorpet-Elevated-Adjustable-Non-Slip-Stainless/dp/B0C3YRH31J?tag=all0ad0-21https://m.media-amazon.com/images/I/41+P1DIyA0L.jpg (3)
- https://www.amazon.com/JOYMODE-women-workout-clothes-Legging/dp/B08766FN91?tag=all0ad0-21https://m.media-amazon.com/images/I/31DoD7LD8EL.jpg (2)
- https://www.amazon.com/Kettlebell-Whiskey-Shaped-Silicone-Melting/dp/B0C5NBXHDF?tag=all0ad0-21https://m.media-amazon.com/images/I/41XwetcdbXL.jpg (1)
- https://www.amazon.com/Kingdom-Come-Backyard-Starship-Book/dp/B0BKBRDCV2?tag=all0ad0-21https://m.media-amazon.com/images/I/51DX-OPQv6L.jpg (1)
- https://www.amazon.com/Kitchen-BAYZZ-Cushioned-Non-Slip-Waterproof/dp/B095GZYG7Z?tag=all0ad0-21https://m.media-amazon.com/images/I/41-vM6JlCeL.jpg (1)
- https://www.amazon.com/KOIOS-Immersion-Multifunctional-Stainless-Titanium/dp/B076GW89V9?tag=all0ad0-21https://m.media-amazon.com/images/I/41YrmEtdu0L.jpg (1)
- https://www.amazon.com/Lady-Orc-Sworn-Book/dp/B0B4BB9B21?tag=all0ad0-21https://m.media-amazon.com/images/I/51VsjpQ+WoL.jpg (1)
- https://www.amazon.com/Large-Multipurpose-Waterproof-Picnic-Shopping/dp/B0CCS1HSMK?tag=all0ad0-21https://m.media-amazon.com/images/I/410kS6OJJHL.jpg (1)
- https://www.amazon.com/Large-Multipurpose-Waterproof-Picnic-Shopping/dp/B0CF58TZ9J?tag=all0ad0-21https://m.media-amazon.com/images/I/410kS6OJJHL.jpg (1)
- https://www.amazon.com/Lay-My-Heart-Angela-Pneuman-ebook/dp/B00FJ5EQ0Q?tag=all0ad0-21https://m.media-amazon.com/images/I/419DBRj4HuL.jpg (1)
- https://www.amazon.com/LeadDock-Ice-Cube-Tray-Lid/dp/B0CB6TN9DY?tag=all0ad0-21https://m.media-amazon.com/images/I/51WpROdbWEL.jpg (1)
- https://www.amazon.com/Learning-Educational-Preschool-Developmental-Montessori/dp/B0BY2HBQLS?tag=all0ad0-21https://m.media-amazon.com/images/I/510R2-67PbL.jpg (3)
- https://www.amazon.com/LEDKINGDOMUS-inches-Driving-Compatible-Pickup/dp/B09176936Z?tag=all0ad0-21https://m.media-amazon.com/images/I/416I+aay3RL.jpg (1)
- https://www.amazon.com/Legend-Randidly-Ghosthound-LitRPG-Adventure/dp/B09CR88G8L?tag=all0ad0-21https://m.media-amazon.com/images/I/51cte+pTRVL.jpg (1)
- https://www.amazon.com/Legend-Randidly-Ghosthound-LitRPG-Adventure/dp/B09NB32VS5?tag=all0ad0-21https://m.media-amazon.com/images/I/51HquIJf4EL.jpg (1)
- https://www.amazon.com/Legend-Randidly-Ghosthound-LitRPG-Adventure/dp/B09WTLH4Z9?tag=all0ad0-21https://m.media-amazon.com/images/I/61j-pJq9blL.jpg (1)
- https://www.amazon.com/LENRUE-Computer-Speakers-Desktop-AUX_Black/dp/B0BRFN13S9?tag=all0ad0-21https://m.media-amazon.com/images/I/41XeSj+qShL.jpg (1)
- https://www.amazon.com/LIANTRAL-Firewood-Outdoor-Upgrade-Fireplace/dp/B0BKSVRW4N?tag=all0ad0-21https://m.media-amazon.com/images/I/51Y9mIZmocL.jpg (1)
- https://www.amazon.com/Lilys-White-Lace-Carolyn-Brown-ebook/dp/B00DTTW5UW?tag=all0ad0-21https://m.media-amazon.com/images/I/51iPZWUaUQL.jpg (1)
- https://www.amazon.com/LISEN-Magnetic-Install-Friendly-Smartphones/dp/B07YRKDF4P?tag=all0ad0-21https://m.media-amazon.com/images/I/51tMoOMiRzL.jpg (2)
- https://www.amazon.com/LJIOEZZI-Balaclava-Weather-Snowboarding-Motorcycling/dp/B0BHVNYM8Z?tag=all0ad0-21https://m.media-amazon.com/images/I/31YRjxzYi8L.jpg (1)
- https://www.amazon.com/LOXP-2C-CAR-Sun-Shade-Umbrella-Medium/dp/B0BR7WLLY4?tag=all0ad0-21https://m.media-amazon.com/images/I/41vWPHUEsJL.jpg (1)
- https://www.amazon.com/LUENX-Trendy-Oversized-Aviator-Sunglasses/dp/B09CMB5D7N?tag=all0ad0-21https://m.media-amazon.com/images/I/41uZsi7kskL.jpg (1)
- https://www.amazon.com/MAGEFY-Eyelashes-Natural-Handmade-Reusable/dp/B0956V789H?tag=all0ad0-21https://m.media-amazon.com/images/I/51UgJTxfm2S.jpg (1)
- https://www.amazon.com/Magnetic-Birthday-Building-Preschool-Montessori/dp/B0BWWPC5MR?tag=all0ad0-21https://m.media-amazon.com/images/I/61UuS8o90ZL.jpg (1)
- https://www.amazon.com/Makartt-Extension-Glitter-Trendy-Builder/dp/B096VQW7NF?tag=all0ad0-21https://m.media-amazon.com/images/I/31hUzSIu6gL.jpg (1)
- https://www.amazon.com/Makeup-Brush-Holder-Travel-Essentials/dp/B0C7G5YXRZ?tag=all0ad0-21https://m.media-amazon.com/images/I/31od+KNxUkL.jpg (1)
- https://www.amazon.com/MaraFansie-Housewarming-Birthday-Anniversary-Graduation/dp/B0BS416GJ3?tag=all0ad0-21https://m.media-amazon.com/images/I/51QjF6NaQ+L.jpg (1)
- https://www.amazon.com/MAREE-Face-Moisturizer-Anti-Wrinkle-Hyaluronic/dp/B0C3LXWJJ7?tag=all0ad0-21https://m.media-amazon.com/images/I/512NgLTHbTL.jpg (1)
- https://www.amazon.com/Matter-Black-Lives-Writing-Yorker/dp/B08TP4YC6S?tag=all0ad0-21https://m.media-amazon.com/images/I/513aBwlCG-L.jpg (1)
- https://www.amazon.com/Mavericks-Craig-Alanson-audiobook/dp/B07GH5ZJ3N?tag=all0ad0-21https://m.media-amazon.com/images/I/51OW+MpwHYL.jpg (1)
- https://www.amazon.com/McAfee-Protection-Exclusive-Monitoring-Subscription/dp/B0BB2N69J8?tag=all0ad0-21https://m.media-amazon.com/images/I/510kxZvrlKL.jpg (1)
- https://www.amazon.com/McAfee-Protection-Unlimited-Device-Download/dp/B07BFRVMMN?tag=all0ad0-21https://m.media-amazon.com/images/I/51qNb5s7JzL.jpg (1)
- https://www.amazon.com/McAfee-Total-Protection-Devices-Subscription/dp/B07K98XDX8?tag=all0ad0-21https://m.media-amazon.com/images/I/51P0zntKKaL.jpg (1)
- https://www.amazon.com/McAfee-Total-Protection-Devices-Subscription/dp/B07K995RWG?tag=all0ad0-21https://m.media-amazon.com/images/I/51hk1owA-eL.jpg (1)
- https://www.amazon.com/McClusky-Battle-Midway-David-Rigby-ebook/dp/B07NJCKM5P?tag=all0ad0-21https://m.media-amazon.com/images/I/41wKgBrbEhL.jpg (1)
- https://www.amazon.com/Meat-Thermometer-Digital-Grilling-Cooking/dp/B0BQ782XNW?tag=all0ad0-21https://m.media-amazon.com/images/I/51cOJyK7rHL.jpg (1)
- https://www.amazon.com/Missing-Molly-Natalie-Barelli-audiobook/dp/B07N7HZ9XJ?tag=all0ad0-21https://m.media-amazon.com/images/I/41G2D08UIgL.jpg (1)
- https://www.amazon.com/Mondays-Not-Coming-audiobook/dp/B07B7897X8?tag=all0ad0-21https://m.media-amazon.com/images/I/51BRoON6IWL.jpg (1)
- https://www.amazon.com/Monster-Wireless-Bluetooth-Headphones-Rotating/dp/B097JZQXXL?tag=all0ad0-21https://m.media-amazon.com/images/I/41RciianoPL.jpg (1)
- https://www.amazon.com/Moolan-Cordless-Portable-Powerful-Rechargeable/dp/B0CB1C743Z?tag=all0ad0-21https://m.media-amazon.com/images/I/41qRyj2A+xL.jpg (1)
- https://www.amazon.com/MORNEEX-Polyester-Bathroom-Waterproof-72X72inches/dp/B0B712Q9QD?tag=all0ad0-21https://m.media-amazon.com/images/I/41ejnaDrS0L.jpg (2)
- https://www.amazon.com/MOYEIKH-Talking-Elderly-Visually-Impaired/dp/B0C4LCMTNN?tag=all0ad0-21https://m.media-amazon.com/images/I/41m7k3YEUXL.jpg (1)
- https://www.amazon.com/Mr-You-Organizer-ModelsStand-Dust-proof-Velvet%EF%BC%8C12L/dp/B082X6BCJG?tag=all0ad0-21https://m.media-amazon.com/images/I/51cRFT9gZCL.jpg (2)
- https://www.amazon.com/MUJERBAY-Massager-Compression-Full-Cover-Fasciitis/dp/B0BWJ4LT32?tag=all0ad0-21https://m.media-amazon.com/images/I/41d7tUceqaL.jpg (1)
- https://www.amazon.com/Musashi-audiobook/dp/B07FXMJCX6?tag=all0ad0-21https://m.media-amazon.com/images/I/515t3Zygd7L.jpg (1)
- https://www.amazon.com/MUSICOZY-Headphones-Bluetooth-Headband-Waterproof/dp/B09NN1MJQS?tag=all0ad0-21https://m.media-amazon.com/images/I/41qxlHs2CTL.jpg (1)
- https://www.amazon.com/My-Dear-Hamilton-audiobook/dp/B077NN1WWF?tag=all0ad0-21https://m.media-amazon.com/images/I/51sBrSA5VfL.jpg (1)
- https://www.amazon.com/NATOLIKE-Pickleball-Lightweight-Fiberglass-Polypropylene/dp/B0BY8JF32S?tag=all0ad0-21https://m.media-amazon.com/images/I/61I+i2U7+sL.jpg (1)
- https://www.amazon.com/Natrol-High-Potency-Antioxidant-Vitamin-Tablets/dp/B08KXGJXR1?tag=all0ad0-21https://m.media-amazon.com/images/I/41y11UVSqkL.jpg (1)
- https://www.amazon.com/Necromancer-Spellmonger-Book-10/dp/B083YVZ8YQ?tag=all0ad0-21https://m.media-amazon.com/images/I/51FELytNyCL.jpg (1)
- https://www.amazon.com/NeoLartes-July-White-Berry-Garlands/dp/B0BWDHKFWV?tag=all0ad0-21https://m.media-amazon.com/images/I/51P3USHQMCL.jpg (1)
- https://www.amazon.com/Neoprene-Dumbbell-Weights-Anti-slip-Anti-roll/dp/B087JDLWLQ?tag=all0ad0-21https://m.media-amazon.com/images/I/31hKC3UgF7L.jpg (1)
- https://www.amazon.com/NEW-Norton-AntiVirus-Plus-Antivirus/dp/B07Q69X7XL?tag=all0ad0-21https://m.media-amazon.com/images/I/51M35ZaPBmL.jpg (1)
- https://www.amazon.com/Nexillumi-LED-Lights-60-75-Inch/dp/B07XBJR7GY?tag=all0ad0-21https://m.media-amazon.com/images/I/519sc2GYDnL.jpg (1)
- https://www.amazon.com/Nicebay-Professional-Dryerwith3-Attachments-Lightweight/dp/B0CBSHRBS6?tag=all0ad0-21https://m.media-amazon.com/images/I/41Og2LDzcML.jpg (1)
- https://www.amazon.com/Night-Sleep-Death-Stars-Novel/dp/B07XY9SKT3?tag=all0ad0-21https://m.media-amazon.com/images/I/51bBRM-4BUL.jpg (1)
- https://www.amazon.com/NuLink-Electric-Inflation-Decoration-110V-120V/dp/B01H2QF6SK?tag=all0ad0-21https://m.media-amazon.com/images/I/41mdv0LnxfL.jpg (1)
- https://www.amazon.com/Nylavee-Computer-Speakers-Soundbar-Connection/dp/B0BZCMM17X?tag=all0ad0-21https://m.media-amazon.com/images/I/41GYynP1rrL.jpg (1)
- https://www.amazon.com/Oakland-Living-Rose-Bird-Bath/dp/B000PAKVJK?tag=all0ad0-21https://m.media-amazon.com/images/I/41MzpuSS3yL.jpg (1)
- https://www.amazon.com/Oasis-033879-001-VersaFiller-Filter-Cartridge/dp/B002WDQGXS?tag=all0ad0-21https://m.media-amazon.com/images/I/41nyJPxi4SL.jpg (1)
- https://www.amazon.com/OBL-Plastic-Durable-Non-deformable-Imitation/dp/B07SKJ946F?tag=all0ad0-21https://m.media-amazon.com/images/I/51Z2NMJGOwL.jpg (1)
- https://www.amazon.com/OCHYIT-Protector-Waterproof-Defender-Analyzer/dp/B0BKL8DWQR?tag=all0ad0-21https://m.media-amazon.com/images/I/41XownI6MdL.jpg (1)
- https://www.amazon.com/Oil-Sprayer-Dispenser-Accessories-Spritzer/dp/B0B93CBCFC?tag=all0ad0-21https://m.media-amazon.com/images/I/51nNMZPYUXL.jpg (1)
- https://www.amazon.com/OKIMO-Wireless-Computer-Ergonomic-Chromebook/dp/B0CC4KLTKM?tag=all0ad0-21https://m.media-amazon.com/images/I/41LJQ8jNxZL.jpg (1)
- https://www.amazon.com/Organizer-Buttonholes-Stretchable-Connectable-Adjustable/dp/B0C22ZMRWC?tag=all0ad0-21https://m.media-amazon.com/images/I/51ql4-4eN8L.jpg (1)
- https://www.amazon.com/Organizer-organizer-Zippers-Blocking-Insert%EF%BC%8C5/dp/B07WMWCBTQ?tag=all0ad0-21https://m.media-amazon.com/images/I/310UEu-zi7L.jpg (1)
- https://www.amazon.com/ORICO-Adapter-External-Converter-Transfer/dp/B0B3MMJ1LB?tag=all0ad0-21https://m.media-amazon.com/images/I/41dfdJx68AL.jpg (1)
- https://www.amazon.com/Original-Certified-Charging-Lightning-Compatible/dp/B0CJDHYYZD?tag=all0ad0-21https://m.media-amazon.com/images/I/41trxkrOxLL.jpg (1)
- https://www.amazon.com/Oupeng-sky-Carabiner-Clip-Ring/dp/B07MSBZ7BZ?tag=all0ad0-21https://m.media-amazon.com/images/I/51Bxk8se22L.jpg (1)
- https://www.amazon.com/Over-Top-Jonathan-Van-Ness-audiobook/dp/B07Q386LM5?tag=all0ad0-21https://m.media-amazon.com/images/I/51rcfpVI5UL.jpg (2)
- https://www.amazon.com/Padfolio-Portfolio-Interview-Document-Organizer/dp/B07VLPS9ZK?tag=all0ad0-21https://m.media-amazon.com/images/I/41CSIOr0ZoL.jpg (1)
- https://www.amazon.com/Pairs-Heavy-Ratchet-Tie-Mount-Crossbar-Easy/dp/B0725Z9LSB?tag=all0ad0-21https://m.media-amazon.com/images/I/41xI-f4Jj9L.jpg (1)
- https://www.amazon.com/Paperwhite-Generation-Signature-Lightweight-Transparent/dp/B0C8B1JJYZ?tag=all0ad0-21https://m.media-amazon.com/images/I/41MpXChQpIL.jpg (1)
- https://www.amazon.com/Paw-Patrol-Collectible-DIE-CAST-Vehicles/dp/B07S6VH6DD?tag=all0ad0-21https://m.media-amazon.com/images/I/41nC9yFe1dL.jpg (1)
- https://www.amazon.com/Peace-nest-Checkered-Checkerboard-Lightweight/dp/B0BX969J3C?tag=all0ad0-21https://m.media-amazon.com/images/I/51D8BO3dasL.jpg (2)
- https://www.amazon.com/Perfect-Run-Book/dp/B09SVMRP12?tag=all0ad0-21https://m.media-amazon.com/images/I/51zkV2RkC2L.jpg (1)
- https://www.amazon.com/Pet-Grooming-Brush-Double-Sided-Blue/dp/B0BRPZY67Z?tag=all0ad0-21https://m.media-amazon.com/images/I/41iA2Z29chL.jpg (1)
- https://www.amazon.com/Pieces-Washed-Reversible-Cooling-Closure/dp/B094FGZ3XD?tag=all0ad0-21https://m.media-amazon.com/images/I/41hX+gmSQvL.jpg (1)
- https://www.amazon.com/PINHEN-Stabilizer-360%C2%B0Rotate-Hands-Free-Compatible/dp/B09N8VL6VT?tag=all0ad0-21https://m.media-amazon.com/images/I/41j3QfO4JLL.jpg (1)
- https://www.amazon.com/Planner-2023-2024-Academic-Calendar-Hardcover/dp/B0BP22KCYV?tag=all0ad0-21https://m.media-amazon.com/images/I/51xfDnKUkSL.jpg (1)
- https://www.amazon.com/Ponytail-hoyuwak-Rhinestone-Accessories-Silver/dp/B0C1GRQNLM?tag=all0ad0-21https://m.media-amazon.com/images/I/51Jl+ePN1vL.jpg (1)
- https://www.amazon.com/Portable-Wireless-Espresso-Machine-Freshly-brewed/dp/B09LCKLYGT?tag=all0ad0-21https://m.media-amazon.com/images/I/21uyv4z55pL.jpg (2)
- https://www.amazon.com/Premom-Quantitative-Ovulation-Predictor-Numerical/dp/B07P7LSW57?tag=all0ad0-21https://m.media-amazon.com/images/I/51dY9dReMhL.jpg (1)
- https://www.amazon.com/Professional-Pedicure-Rosmax-Stainless-Washable/dp/B08TM7TH1N?tag=all0ad0-21https://m.media-amazon.com/images/I/519tcTL-K8L.jpg (1)
- https://www.amazon.com/Projector-Bluetooth-15000Lumens-Portable-Compatible/dp/B0CGXHVB5D?tag=all0ad0-21https://m.media-amazon.com/images/I/414hYl+AJuL.jpg (1)
- https://www.amazon.com/Projector-Control-Bluetooth-Dimmable-Projection/dp/B09F95JS41?tag=all0ad0-21https://m.media-amazon.com/images/I/61GYRolZ-9L.jpg (1)
- https://www.amazon.com/Projector-HOMPOW-Bluetooth-Correction-Compatible/dp/B0BCKV1VHX?tag=all0ad0-21https://m.media-amazon.com/images/I/616j3cS2O9L.jpg (1)
- https://www.amazon.com/Protector-Coverage-Protection-Installation-Specially/dp/B0B87THFLK?tag=all0ad0-21https://m.media-amazon.com/images/I/41tlgaNVLCL.jpg (1)
- https://www.amazon.com/Protectors-Furniture-Scratches-Hardwood-Large/dp/B0CHB4ZR22?tag=all0ad0-21https://m.media-amazon.com/images/I/51UIaW9XlXL.jpg (1)
- https://www.amazon.com/Purifier-Purifiers-VEWIOR-Settings-Ultra-Quiet/dp/B0B41Z7B6H?tag=all0ad0-21https://m.media-amazon.com/images/I/41o0rCSrKcL.jpg (1)
- https://www.amazon.com/Purifiers-Purifier-Aromatherapy-Function-Filtration/dp/B0C5GCPDV2?tag=all0ad0-21https://m.media-amazon.com/images/I/41KvpYD7k5L.jpg (1)
- https://www.amazon.com/QAWDAWM-Conduction-Headphones-Bluetooth-Waterproof/dp/B0CGR1799N?tag=all0ad0-21https://m.media-amazon.com/images/I/41trzwTzdKL.jpg (1)
- https://www.amazon.com/REDESS-Beanie-Women-Winter-Slouchy/dp/B0BZVDHFNJ?tag=all0ad0-21https://m.media-amazon.com/images/I/51hHyl+rkWL.jpg (1)
- https://www.amazon.com/Robot-Vacuum-Mop-Combo-Self-Charging/dp/B0CD3XTMS1?tag=all0ad0-21https://m.media-amazon.com/images/I/518O5sALu1L.jpg (2)
- https://www.amazon.com/RONGPRO-Combination-Carpenter-Zinc-Alloy-Die-Casting/dp/B09GVQRZVK?tag=all0ad0-21https://m.media-amazon.com/images/I/41uHEayHMEL.jpg (2)
- https://www.amazon.com/ROOMLIFE-Chenille-Slipcover-Loveseat-Sectional/dp/B0BJ5T5Z91?tag=all0ad0-21https://m.media-amazon.com/images/I/51VNyhUtziL.jpg (1)
- https://www.amazon.com/Ryan-Rule-York-Ruthless-Book/dp/B0BPJSLNDX?tag=all0ad0-21https://m.media-amazon.com/images/I/51o9mZQpbgL.jpg (1)
- https://www.amazon.com/Sandstorm-Street-Rats-Aramoor-Book/dp/B09QDYGXGT?tag=all0ad0-21https://m.media-amazon.com/images/I/61g7nbsvDiL.jpg (1)
- https://www.amazon.com/Santoku-Knife-Stainless-Ergonomic-Restaurant/dp/B0865TNBKC?tag=all0ad0-21https://m.media-amazon.com/images/I/41bVfVBEhOL.jpg (1)
- https://www.amazon.com/SATC-Woodworking-Carpenters-Gardening-Resistant/dp/B09WYGJJ3F?tag=all0ad0-21https://m.media-amazon.com/images/I/31U+zqjEzNL.jpg (1)
- https://www.amazon.com/Scissors-ULG-Hairdressing-Stainless-Detachable/dp/B09ZTZYDT2?tag=all0ad0-21https://m.media-amazon.com/images/I/315+PnPQhmL.jpg (1)
- https://www.amazon.com/SeaVees-Mens-Standard-Casual-Sneaker/dp/B008TUCU1A?tag=all0ad0-21https://m.media-amazon.com/images/I/31z4PJ-dnQL.jpg (1)
- https://www.amazon.com/Security-Lighting-Waterproof-Outdoor-Basketball/dp/B09GV2B545?tag=all0ad0-21https://m.media-amazon.com/images/I/41Hh9Px9UzL.jpg (2)
- https://www.amazon.com/Shadow-Dark-Queen-Serpentwar-Saga/dp/B07YCT8PKM?tag=all0ad0-21https://m.media-amazon.com/images/I/517+deIbkiL.jpg (1)
- https://www.amazon.com/Shadowplay-Spellmonger-Legacy-Secrets-Book/dp/B09DZ4S8MG?tag=all0ad0-21https://m.media-amazon.com/images/I/51mV-QcOzOL.jpg (1)
- https://www.amazon.com/Shamrocks-Bedroom-Bathroom-Kitchen-Hallway/dp/B07ZV5DSTN?tag=all0ad0-21https://m.media-amazon.com/images/I/51J0KqPk6ML.jpg (2)
- https://www.amazon.com/Silicone-Reusable-AiKanbo-Airtight-Preservation/dp/B09X1LXS9B?tag=all0ad0-21https://m.media-amazon.com/images/I/41fNI3t5hYS.jpg (1)
- https://www.amazon.com/Sixriver-Crimper-Straightener-Crimping-Volumizing/dp/B0C85XZFM8?tag=all0ad0-21https://m.media-amazon.com/images/I/51OrfENeNCL.jpg (1)
- https://www.amazon.com/Skyfoot-Adjustable-Increase-Insoles-Cushioning/dp/B0BN5V3PPF?tag=all0ad0-21https://m.media-amazon.com/images/I/41uwN2FiiiL.jpg (1)
- https://www.amazon.com/skysen-Magnetic-Decorative-Handles-Hardware/dp/B07L72D7FX?tag=all0ad0-21https://m.media-amazon.com/images/I/51AIynaJumL.jpg (1)
- https://www.amazon.com/STAR-WARS-SW-Halloween-Wookiee/dp/B0BHZVTNQV?tag=all0ad0-21https://m.media-amazon.com/images/I/411fjZsBYrL.jpg (1)
- https://www.amazon.com/Stens-375-402-Black-Decker-82-020/dp/B01H5K2QSQ?tag=all0ad0-21https://m.media-amazon.com/images/I/21Tkj5Btb0L.jpg (1)
- https://www.amazon.com/Stickers-Bottles-Waterproof-Animals-Skateboard/dp/B09S3JSNV3?tag=all0ad0-21https://m.media-amazon.com/images/I/61E2JiiBkML.jpg (1)
- https://www.amazon.com/Still-Just-Geek-Annotated-Memoir/dp/B09HZB3WGP?tag=all0ad0-21https://m.media-amazon.com/images/I/51Ee05wyCwL.jpg (1)
- https://www.amazon.com/Straightener-MiroPure-Straightening-Anti-Scald-Temperature/dp/B06XGXP9RP?tag=all0ad0-21https://m.media-amazon.com/images/I/41okvbcUEnL.jpg (1)
- https://www.amazon.com/Summit-Treestands-Replacement-Cables-Climbing/dp/B001BAGLXI?tag=all0ad0-21https://m.media-amazon.com/images/I/41vANZDPuCL.jpg (1)
- https://www.amazon.com/Support-Car-Car-Support-Memory-Car-Driving/dp/B07MV5X84K?tag=all0ad0-21https://m.media-amazon.com/images/I/51iEP2LoKmL.jpg (1)
- https://www.amazon.com/Surface-Charger-Microsoft-Compatible-Laptop/dp/B0BW41H1W2?tag=all0ad0-21https://m.media-amazon.com/images/I/31Xt8mDjKyL.jpg (1)
- https://www.amazon.com/Survival-Essentials-Tactical-Emergency-Activities/dp/B0BFFC8ZTV?tag=all0ad0-21https://m.media-amazon.com/images/I/512QQyOIcjL.jpg (1)
- https://www.amazon.com/SwaggWood-Certified-Lightning-Charging-Compatible/dp/B0CFQF6LS6?tag=all0ad0-21https://m.media-amazon.com/images/I/41vq56QWFNL.jpg (1)
- https://www.amazon.com/Tablecloth-Disposable-Surfboard-Rectangle-Birthday/dp/B09X2GK6Z7?tag=all0ad0-21https://m.media-amazon.com/images/I/51M30CIsW2L.jpg (1)
- https://www.amazon.com/Tanming-Womens-Seamless-Workout-Running/dp/B0BHY73PWB?tag=all0ad0-21https://m.media-amazon.com/images/I/310AJZGSfCL.jpg (1)
- https://www.amazon.com/Tear-off-Productivity-Anna-Marie-Collections/dp/B09GDDCMJP?tag=all0ad0-21https://m.media-amazon.com/images/I/41yZVQwPEZL.jpg (2)
- https://www.amazon.com/Textures-Graphite-Charcoal-Steven-Pearce-ebook/dp/B01N7Y0XP5?tag=all0ad0-21https://m.media-amazon.com/images/I/61XIPXXBL5L.jpg (1)
- https://www.amazon.com/The-Beginning-of-Everything-audiobook/dp/B081NXJVT5?tag=all0ad0-21https://m.media-amazon.com/images/I/51aG06izsLL.jpg (1)
- https://www.amazon.com/The-Enlightenment/dp/B07VHFHN3Y?tag=all0ad0-21https://m.media-amazon.com/images/I/51ArbS5NSDL.jpg (1)
- https://www.amazon.com/The-Good-Lie/dp/B08QVNGF3M?tag=all0ad0-21https://m.media-amazon.com/images/I/51UPMGqzseS.jpg (1)
- https://www.amazon.com/Thermal-Moisture-Wicking-Breathable-Charcoal/dp/B0929CZSL2?tag=all0ad0-21https://m.media-amazon.com/images/I/61GFFLF2InL.jpg (1)
- https://www.amazon.com/Tiny-Worlds-flashcards-Preschoolers-FlashCards/dp/9811186480?tag=all0ad0-21https://m.media-amazon.com/images/I/51Du0jKtPzL.jpg (1)
- https://www.amazon.com/TOZO-G1-Headphones-Sensitivity-Low-Latency/dp/B0B31GZW61?tag=all0ad0-21https://m.media-amazon.com/images/I/41E2gk95+aL.jpg (1)
- https://www.amazon.com/Traffic-Secrets-Underground-Playbook-Customers/dp/B08B9XH6KH?tag=all0ad0-21https://m.media-amazon.com/images/I/51hWa7NS0NL.jpg (1)
- https://www.amazon.com/Twinkle-Star-Decorative-Waterproof-Decorations/dp/B098JY29L7?tag=all0ad0-21https://m.media-amazon.com/images/I/616wtcSojML.jpg (3)
- https://www.amazon.com/TWOPAN-Docking-Station-Charging-Reader/dp/B08DP397VJ?tag=all0ad0-21https://m.media-amazon.com/images/I/51uMUogb87L.jpg (1)
- https://www.amazon.com/ULA-YUAN-Earrings-Sterling-Lightweight-Zirconia/dp/B0C4TD5XT1?tag=all0ad0-21https://m.media-amazon.com/images/I/41xB7mwzhLL.jpg (2)
- https://www.amazon.com/Ultrean-Scale%EF%BC%8C33lb-Graduation-Rechargeable-Function/dp/B0C4T7DYPF?tag=all0ad0-21https://m.media-amazon.com/images/I/51AeRXTVp5L.jpg (1)
- https://www.amazon.com/undercoat-grooming-couch-remover-cleaning/dp/B0BQXW1KKT?tag=all0ad0-21https://m.media-amazon.com/images/I/412YRiMjcUL.jpg (1)
- https://www.amazon.com/Unfinished-Large-Unpainted-Birthday-Decoration/dp/B0C8YQCQBY?tag=all0ad0-21https://m.media-amazon.com/images/I/31bPd6gVmSL.jpg (1)
- https://www.amazon.com/UniLiGis-Washable-Backpack-Adjustable-Drawstring/dp/B08CDZDKP2?tag=all0ad0-21https://m.media-amazon.com/images/I/413CAK6mBXL.jpg (2)
- https://www.amazon.com/Uniquewise-QI003353R-L-Handcrafted-Burgundy-Natural/dp/B07F866473?tag=all0ad0-21https://m.media-amazon.com/images/I/313YcWeXFoL.jpg (2)
- https://www.amazon.com/VacLife-Cordless-Charger-350CFM-Electric-High-Speed/dp/B0C6MZZLTT?tag=all0ad0-21https://m.media-amazon.com/images/I/41bEaK78nKL.jpg (1)
- https://www.amazon.com/VAV-Infrared-Strong-Diffuser-Concentrator/dp/B07H8SR9K7?tag=all0ad0-21https://m.media-amazon.com/images/I/41uNl6-KSPL.jpg (1)
- https://www.amazon.com/Vilucks-Reusable-Universal-Microfiber-Cloths/dp/B09TPPK2T6?tag=all0ad0-21https://m.media-amazon.com/images/I/21tCfu9A9wL.jpg (1)
- https://www.amazon.com/Vooii-iPhone-Silicone-Protective-Microfiber/dp/B07Z7LY135?tag=all0ad0-21https://m.media-amazon.com/images/I/41LTfdLnNVL.jpg (2)
- https://www.amazon.com/Walking-Sam-Father-Hundred-Across/dp/B0BJ14HHVD?tag=all0ad0-21https://m.media-amazon.com/images/I/51xw7IcZbAL.jpg (1)
- https://www.amazon.com/Watchers-gripping-debut-horror-novel-ebook/dp/B08TP9ZQY5?tag=all0ad0-21https://m.media-amazon.com/images/I/41g5T7Vj8vL.jpg (1)
- https://www.amazon.com/Waterproof-Exquisitely-Lengthening-Thickening-Smudge-Proof/dp/B09FJK67YH?tag=all0ad0-21https://m.media-amazon.com/images/I/51X6cb5qVvL.jpg (1)
- https://www.amazon.com/Waterproof-Toddler-Automatic-Sprinkler-Induction/dp/B0BFB53X61?tag=all0ad0-21https://m.media-amazon.com/images/I/51hZjr8pPCL.jpg (2)
- https://www.amazon.com/Webroot-Internet-Antivirus-Protection-Subscription/dp/B07DDL3N69?tag=all0ad0-21https://m.media-amazon.com/images/I/41engcvUs-L.jpg (1)
- https://www.amazon.com/Welcome-Retriever-Sunflowers-Farmhouse-Decorations/dp/B0BX4CGRZ6?tag=all0ad0-21https://m.media-amazon.com/images/I/51mDBvSQDgL.jpg (1)
- https://www.amazon.com/Westinghouse-6361700-One-Light-Barnwood-Accents/dp/B07FV24JKY?tag=all0ad0-21https://m.media-amazon.com/images/I/31CAM-d4pHL.jpg (1)
- https://www.amazon.com/whall-Cordless-Upgraded-Brushless-Lightweight/dp/B0CCS6K9ZQ?tag=all0ad0-21https://m.media-amazon.com/images/I/41yccuwbFUL.jpg (1)
- https://www.amazon.com/Wildfire-Street-Rats-Aramoor-Book/dp/B09TQ2N654?tag=all0ad0-21https://m.media-amazon.com/images/I/616qu3UwE1L.jpg (1)
- https://www.amazon.com/Women-Socks-Winter-Womens-Pairs/dp/B0B51QC6YX?tag=all0ad0-21https://m.media-amazon.com/images/I/51ewD5NWbWL.jpg (1)
- https://www.amazon.com/Womens-Shoulder-Striped-Jumpsuits-Rompers/dp/B09SJ1G85L?tag=all0ad0-21https://m.media-amazon.com/images/I/41YYqXXx5dL.jpg (1)
- https://www.amazon.com/Wozukia-Watercolor-MatInteresting-Amphibians-Decoration/dp/B0BYF9D2FX?tag=all0ad0-21https://m.media-amazon.com/images/I/518pUiLOefL.jpg (1)
- https://www.amazon.com/X-cosrack-Organizer-Adjustable-Multifunctional-Cabinets/dp/B08BZMX161?tag=all0ad0-21https://m.media-amazon.com/images/I/51pk2BkIxjL.jpg (1)
- https://www.amazon.com/XIOYIG-Tabletop-Portable-Concrete-Fireplace/dp/B0BJPD1Y4S?tag=all0ad0-21https://m.media-amazon.com/images/I/31ESaKZWI5L.jpg (1)
- https://www.amazon.com/Y-W-Y-Bracelet-Mermaid-Jewelry-Supplies/dp/B095Y3SGBT?tag=all0ad0-21https://m.media-amazon.com/images/I/81mmuW14WML.jpg (1)
- https://www.amazon.com/YaberAuto-Battery-Portable-Extended-Charging/dp/B0C4Y9NTQT?tag=all0ad0-21https://m.media-amazon.com/images/I/51GZ73w-xSL.jpg (1)
- https://www.amazon.com/Yicostar-Walking-Collapsible-Portable-Dispenser/dp/B08XYWNVPP?tag=all0ad0-21https://m.media-amazon.com/images/I/31XbaAaEM-L.jpg (1)
- https://www.amazon.com/YONHISDAT-Rechargerable-Circulation-360%C2%B0Rotation-Vehicles/dp/B0C1G12PFH?tag=all0ad0-21https://m.media-amazon.com/images/I/412XGJmpeoL.jpg (1)
- https://www.amazon.com/YORKING-Headlights-Rectangular-Freightinger-Oldsmobile/dp/B07CF7JVTN?tag=all0ad0-21https://m.media-amazon.com/images/I/61XCciZBQTL.jpg (1)
- https://www.amazon.com/YOU-WIZV-Keychain-Cartoon-Accessory/dp/B0BPJ3RJL6?tag=all0ad0-21https://m.media-amazon.com/images/I/41kdT+esfOL.jpg (1)
- https://www.amazon.com/YOYI-Sandproof-Lightweight-Waterproof-Festivals/dp/B0C2SRR115?tag=all0ad0-21https://m.media-amazon.com/images/I/61NsvKATXeL.jpg (1)
Random Posts
Popular Posts
Samsung's 128 TB-Class BM1743 Enterprise SSD Displayed at FMS 2024 Samsung had quietly launched its BM1743 enterprise QLC SSD last month with a hefty 61.44 TB SKU. At FMS 2024, the company had the even larger 122.88 TB version of that SSD on display, alongside a few recorded benchmarking sessions. Compared to the previous generation, the BM1743 comes with a 4.1x improvement in I/O performance, improvement in data retention, and a 45% improvement in power efficiency for sequential writes.
The 128 TB-class QLC SSD boasts of sequential read speeds of 7.5 GBps and write speeds of 3 GBps. Random reads come in at 1.6 M IOPS, while 16 KB random writes clock in at 45K IOPS. Based on the quoted random write access granularity, it appears that Samsung is using a 16 KB indirection unit (IU) to optimize flash management. This is similar to the strategy adopted by Solidigm with IUs larger than 4K in their high-capacity SSDs.
A recorded benchmark session on the company's PM9D3a 8-channel Gen 5 SSD was also on display.
The SSD family is being promoted as a mainstream option for datacenters, and boasts of sequential reads up to 12 GBps and writes up to 6.8 GBps. Random reads clock in at 2 M IOPS, and random writes at 400 K IOPS.
Available in multiple form-factors up to 32 TB (M.2 tops out at 2 TB), the drive's firmware includes optional support for flexible data placement (FDP) to help address the write amplification aspect.
The PM1753 is the current enterprise SSD flagship in Samsung's lineup. With support for 16 NAND channels and capacities up to 32 TB, this U.2 / E3.S SSD has advertised sequential read and write speeds of 14.8 GBps and 11 GBps respectively. Random reads and writes for 4 KB accesses are listed at 3.4 M and 600 K IOPS.
Samsung claims a 1.7x performance improvement and a 1.7x power efficiency improvement over the previous generation (PM1743), making this TLC SSD suitable for AI servers.
The 9th Gen. V-NAND wafer was also available for viewing, though photography was prohibited. Mass production of this flash memory began in April 2024.
Storage













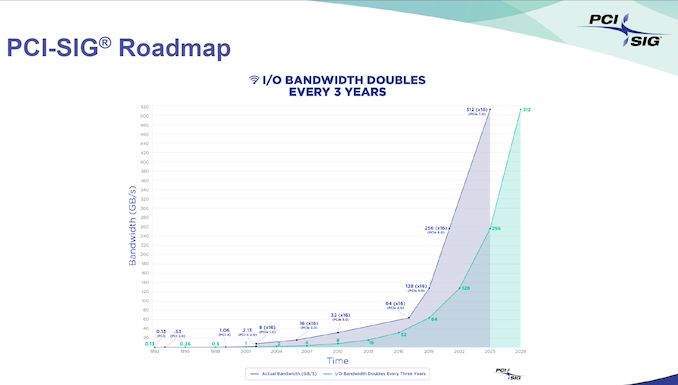
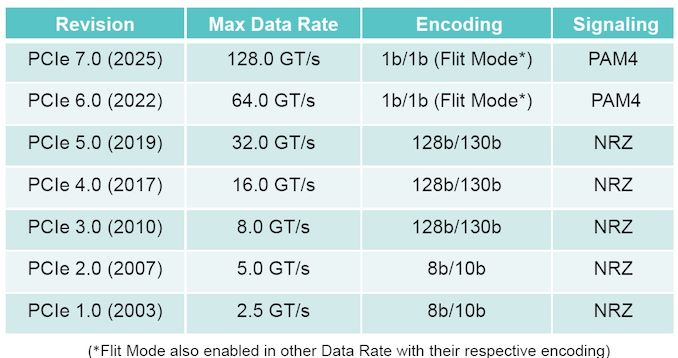

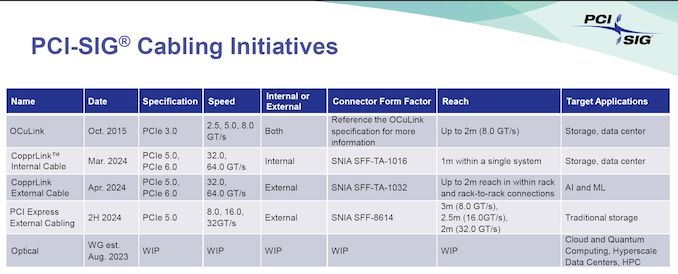

0 Comments